Heinrich-Heine-Gymnasium
Facharbeit aus dem Fach Physik
Thema: Transistoren
Verfasser: Stephan Hachinger
Kursleiterin: Frau Warmbein
Inhalt:
0) Kurze Bemerkung zur Internetausgabe incl. Disclaimer
1) Einführung zum ThemaSeite 3
2) Geschichte und Bedeutung des TransistorsSeite 4
2.1) Geschichte des Transistor als Ersatz für die Röhre
2.2) Weiterentwicklungen; Wirkung auf unsere moderne Gesellschaft
3) Physikalische Grundlagen zum Verständnis des TransistorsSeite 7
3.1) Leitungsmechanismen in Halbleitern
3.2) Der P-N-Übergang; die Diode und ihre Funktion
3.3) Bipolartransistor: Funktionsweise am Beispiel des NPN-Typs
3.4) Funktion von Feldeffekttransistoren; unipolar/bipolar-Namensgebung
3.5) Ausblick: andere Transistortypen
4) Herstellung von TransistorenSeite 19
4.1) Gewinnung reiner Halbleitersubstanzen
4.2) Ältere Produktionsverfahren für Bipolartypen
4.3) Das Planarverfahren
5) Kennlinien u. weitere Charakteristika versch. BipolartypenSeite 27
5.1) Messanordnung; Auswertungs- und Vergleichsverfahren
5.2) Ube-Ibe-Kennlinien
5.3) Ibe-Ice-Kennlinien; Ice-B-Kennlinien
5.4) Uce-Ice-Kennlinien
5.5) Vierquadrantendarstellung der Kennlinienfelder
6) QuellenverzeichnisSeite 43
0) Vorwort zur Internetausgabe / Disclaimer
Diese Facharbeit ist - bis auf sehr kleine Veränderungen (es wurden vor allem die copyrightgeschützten Bilder ersetzt) -
gleich dem Original, welches im Februar 2001 am Heinrich-Heine-Gymnasium, München-Neuperlach abgegeben wurde. Die Facharbeit
wurde mit 15 Punkten bewertet; dennoch wird meinerseits verständlicherweise keine Gewähr dafür übernommen, dass die Arbeit völlig
fehlerlos ist; Fehler können sich schon beim Umsetzen in HTML mit den genannten geringen Verõnderungen viel zu schnell einschleichen, als dass man so eine Garantie abgeben könnte.
Der Grund der Veröffentlichung im Web ist nicht, dass sich andere Schüler, die eine Facharbeit schreiben müssen,
etwa dieses Dokument einfach ausdrucken und einreichen sollen; dies wäre eine, ehrlich gesagt, ziemlich feige Art, sich vor einer Facharbeit
zu drücken. Jedoch hat mich meine Kursleiterin, Frau Warmbein, freundlicherweise dazu angeregt, die Arbeit einfach als Informationsquelle ins Internet zu stellen,
und ich denke ebenfalls, dass sie gerade für ein Grundverständnis des Transistors, wie man es als Mittel-/Oberstufler öfters benötigt,
vielleicht eine Hilfe darstellen kann. So hoffe ich, dass sie dem Einen oder Anderen, der etwas über Transistoren erfahren möchte, eine Freude sein wird.
▄ber Anregungen und Verbesserungsvorschlõge per Email, vor allem bez³glich
meines minimal-html-Stils w³rde ich mich sehr freuen.
Besonderer Dank gilt folgenden Lehrern des HHG:
-Frau Warmbein für die gute, herzliche Betreuung und div. Hilfe
-Herrn Greiter für Hilfe mit Geräten etc.
-Herrn Jordan u.A. für ein zentrales Gesprõch zur Theorie
1) Einführung zum Thema
Transistoren sind, seitdem sie im Jahre 1947 erfunden wurden und bald darauf Einzug in die
verschiedenartigsten elektronischen Geräte fanden, kaum mehr aus unserem Leben wegzudenken.
Man begegnet ihnen überall, ob in Computern, Kinderspielzeug oder der heimischen HIFI-Anlage.
Auch hat wohl jeder passionierte Widerstandsgärtner (Hobby-Elektroniker), wie ich es bin, schon
einmal mit ihnen und ihren vielseitigen Einsatzmöglichkeiten Bekanntschaft gemacht.
Im Rahmen dieser Facharbeit möchte ich
vor allem die internen physikalischen Vorgänge im Bipolartransistor und den unipolaren
Transistoren näher beleuchten. Dieser Theorieteil der Arbeit gründet sich hauptsächlich
auf ein anschauliches Bild von den im Transistor ablaufenden Vorgängen. Rechnerische Modelle
würden durchwegs eine Argumentation auf Universitätsniveau erfordern; das dazu nötige
komplizierte Wissen der Festkörperphysik müsste man also von fast Null aus aufbauen; somit
konnte diese Art der Betrachtung leider nicht ermöglicht werden. Die schlüssige Erläuterung
anschaulicher Modellvorstellungen, um die ich mich stattdessen bemüht habe, soll ihre Stärken
in der Schaffung eines besseren Verständnisses für die so erklärbaren Vorgänge zeigen; bei
schwierigeren Effekten im Transistor hat diese Argumentationsart aber leider auch ihre klar
erklärbaren Grenzen, und natürlich kann man von ihr keine exakte quantitative Beschreibung
der physikalischen Vorgänge erwarten. Daher ist die Darstellung der Transistorcharakteristika
auch in zwei Teile gegliedert: Der erste gründet sich auf die Vorstellung vom Transistor und
geht ausführlich auf die Theorie ein, und der zweite zeigt die komplizierteren Effekte an den
von mir erstellten Transistorkennlinien wenigstens auf.
Nun noch ein paar Worte zur Grobgliederung:
Am Anfang der Arbeit findet sich ein Einblick in die Geschichte des Transistors, de
den immensen Einfluss dieses Bauelementes auf unsere moderne Gesellschaft und somit
unser Leben ahnen lässt. Dann möchte ich auf die physikalischen Eigenschaften von
Halbleitern und Halbleiterübergängen eingehen, um unter Vorraussetzung dieses Vorwissens
schließlich die Funktion der Transistoren zu schildern. Nach dieser Darstellung und einer
doch sehr ausführlich ausgefallenen Sektion über die Transistorproduktion finden sich von mir
aufgenommene Transistorkennlinien von Bipolartransistoren mit einer Beschreibung der nötigen
Versuchsanordnungen und Erklärung einiger aus den Kurven ersichtlicher Charakteristika dieses
Transistortyps. Als Abschluss beinhaltet diese Sektion noch einen Ausblick auf die
Vierquadrantendarstellung der Kennlinienfelder, welche für die Schaltungskonzeption von
großer Bedeutung ist.
2) Die Geschichte des Transistors
2.1) Der Ersatz für die Röhre - Entwicklung des Transistors
Die Vakuumtrioden, die seit 1906 vor der Entwicklung des Transistors als elektrische Verstärker
oder Schalter eingesetzt wurden, hatten, wie sich bald herausstellte, einige gravierende Nachteile:
- Die Heizwendel produziert unnötig aus wertvoller elektrischer Energie Wärme und neigt zum Durchbrennen.
- Die Röhre bennötigt viel Platz und ist zerbrechlich.
- Die Röhre benötigt eine sehr hohe Spannung, um Elektronen von der Kathode zur Anode zu ziehen.
Die treibende Kraft aus der Wirtschaft, die sich ein anderes Bauelement zum Ersatz der Röhre
wünschte, war die amerikanische Telekommunikationsindustrie, die Verstärker zum Beispiel für
lange Leitungen benötigte. Mitarbeiter der Bell Laboratories, die für eine große
Telefongesellschaft die Entwicklung bewerkstelligten, stellten daher 1945 ein Team von
Wissenschaftlern auf, das einen Röhrenersatz auf Halbleiterbasis entwickeln sollte.
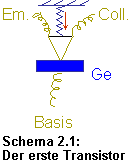 Der Teamleiter, William Bradford
Shockley, versuchte schon im Frühjahr 45, einen Prototyp eines Feldeffekt-basierten
Verstärkerbauteils zu bauen, dieser Versuch mißlang jedoch. Schließlich konnten zwei
Physiker, der brilliante Theoretiker John Bardeen, und der Experimentalphysiker Walter Houser
Brattain, die Entwicklung mit viel trial and error vorantreiben und 1947 den ersten
point-contact-transistor (zu deutsch: Spitzentransistor) entwickeln. Dieser bestand aus
Goldstreifen auf einem Plastikdreieck, das mit einer entgrateten Spitze auf einer
Germaniumplatte des n-Typs aufstieß (Abb.2.1). Durch Anlegen einer positiven Spannung gegenüber der Basis an den Emitter wurden, was dem heutigen Prinzip des Transistors weitgehend ähnlich ist, aus dem positiven Goldemitter Löcher in die Basis injiziert, wodurch man
den Widerstand zwischen dem Kollektor und dem Germaniumkristall bei negativer Vorspannung
des Kollektors gegenüber der Basis beeinflussen konnte.
Shockley konnte sich dann etwas später wieder an die Spitze der Entwicklung setzen,
als er den Bipolartransistor in Sandwichbauweise, wie er in etwa heute miniaturisiert
und in einem Plastikgehäuse untergebracht gebräuchlich ist, erdachte. Es dauerte dann
noch ca. zwei Jahre, bis er zum ersten mal gebaut werden konnte.
Der Teamleiter, William Bradford
Shockley, versuchte schon im Frühjahr 45, einen Prototyp eines Feldeffekt-basierten
Verstärkerbauteils zu bauen, dieser Versuch mißlang jedoch. Schließlich konnten zwei
Physiker, der brilliante Theoretiker John Bardeen, und der Experimentalphysiker Walter Houser
Brattain, die Entwicklung mit viel trial and error vorantreiben und 1947 den ersten
point-contact-transistor (zu deutsch: Spitzentransistor) entwickeln. Dieser bestand aus
Goldstreifen auf einem Plastikdreieck, das mit einer entgrateten Spitze auf einer
Germaniumplatte des n-Typs aufstieß (Abb.2.1). Durch Anlegen einer positiven Spannung gegenüber der Basis an den Emitter wurden, was dem heutigen Prinzip des Transistors weitgehend ähnlich ist, aus dem positiven Goldemitter Löcher in die Basis injiziert, wodurch man
den Widerstand zwischen dem Kollektor und dem Germaniumkristall bei negativer Vorspannung
des Kollektors gegenüber der Basis beeinflussen konnte.
Shockley konnte sich dann etwas später wieder an die Spitze der Entwicklung setzen,
als er den Bipolartransistor in Sandwichbauweise, wie er in etwa heute miniaturisiert
und in einem Plastikgehäuse untergebracht gebräuchlich ist, erdachte. Es dauerte dann
noch ca. zwei Jahre, bis er zum ersten mal gebaut werden konnte.
 1948 wurde die Erfindung des Spitzentransistors (über die Entstehung des Namens Transistor gibt es unterschiedliche Ansichten) von den Bell Labs publik gemacht, 1951 die Erfindung des Sandwich-Bipolartransistors. Im Jahre 1956 erhielten die drei Väter des Transistors für ihre Erfindungen den Nobelpreis für Physik.
1948 wurde die Erfindung des Spitzentransistors (über die Entstehung des Namens Transistor gibt es unterschiedliche Ansichten) von den Bell Labs publik gemacht, 1951 die Erfindung des Sandwich-Bipolartransistors. Im Jahre 1956 erhielten die drei Väter des Transistors für ihre Erfindungen den Nobelpreis für Physik.
Zu den ersten Firmen in Amerika, die nach 1950 Transistoren produzierten, gehörten die Röhrenersteller General Electric, Philco, Raytheon, RCA, Sylvania und Westinghouse, aber auch Motorola und TI. Um 1957 kam Fairchild Semiconductors, die Mutter der Halbleiterindustrie hinzu, und 1969 wurde Intel gegründet. In Europa waren die Pioniere Philips (Transistorfertigung ab 1952), R.P.C. (Gründung 1955), SGS (gegründet 1957), ATES (Produktion ab 1960) und Siemens, das in den 60er Jahren ebenfalls mit der Fertigung begann. Während in den 50er und 60er Jahren der Transistor vor allem beim Militär zum Einsatz gelangte, setzte er sich bald auch allgemein durch. Einige Firmen wie SONY konzentrierten sich nicht darauf, den Transistor an das Militär oder Computerhersteller zu verkaufen, sondern verkauften stattdessen platzsparende, auch batteriebetriebene Transistorradios in sehr hohen Stückzahlen an die Masse, und unter anderem mit ihnen verbreitete sich der immer preisgünstigere Transistor immens. Heute bekommt man einen Siliziumtransistor für 20 Pfennige in jedem guten Elektronikgeschäft.
Technisch ist das Funktionsprinzip des Transistors bis jetzt gleich geblieben. Siliziumtypen
setzten sich gegenüber den Germanium-basierten Typen durch. Zum Bipolartransistor gesellten
sich noch unter anderem die anders funktionierenden Feldeffekttransistoren (FETs), deren
Fertigung man erst in den 60er bis 70er Jahren in den Griff bekam.
2.2) Vom Transistor zum IC und Prozessor - Die Weiterentwicklung
 Im Jahre 1958 brachte Jack Kilby von TI das erste mal eine Schaltung aus mehreren
Transistoren auf einem Halbleiterkristall unter, und 1959 erfand Robert Noyce ein
ähnliches Bauteil unabhängig von Kilby bei Fairchild, wo man 1961 auch als erste Firma
die industrielle Fertigung von integrierten Flipflop-Schaltungen begann. Heute sind
solcherlei Bauelemente, ICs (integrated circuit, integrierte Schaltung, Abb. 2.3) genannt,
in fast jedem elektronischen Gerät anzutreffen. Mit der Zeit konnten in ihnen sehr komplexe
Schaltungen untergebracht werden, da die mögliche Transistordichte und Miniaturisierung durch
bessere Fertigungstechniken immer weiter erhöht wurde. Das Ergebnis dieser Entwicklungen sind
neben diversen Elektrogeräten mit minimierter Anzahl an diskreten (einzelnen) Transistoren
auch die heutigen Mikroprozessoren, die unter anderem die Basis der PCs darstellen. Ohne
diese programmierbaren hochintegrierten Transistorschaltungen, wäre der Computer für
Jedermann und auch die damit verbundene Gesellschaftsentwicklung undenkbar. Die Anzahl
der Transistoren in Prozessoren steigt ständig und verdoppelt sich in konstanten
Zeitabständen ungefähr, so dass der Pentium II-Prozessor schon 7,5 Millionen Transistoren
auf einem Chip enthielt, während der erste Intel-Prozessor 4004 im Jahre 1971 noch mit
2300 Transistoren rechnete. Auch wird die Schaltgeschwindigkeit (Taktung) der meist auf FETs
basierten Prozessoren immer höher und die Computer damit immer schneller.
Im Jahre 1958 brachte Jack Kilby von TI das erste mal eine Schaltung aus mehreren
Transistoren auf einem Halbleiterkristall unter, und 1959 erfand Robert Noyce ein
ähnliches Bauteil unabhängig von Kilby bei Fairchild, wo man 1961 auch als erste Firma
die industrielle Fertigung von integrierten Flipflop-Schaltungen begann. Heute sind
solcherlei Bauelemente, ICs (integrated circuit, integrierte Schaltung, Abb. 2.3) genannt,
in fast jedem elektronischen Gerät anzutreffen. Mit der Zeit konnten in ihnen sehr komplexe
Schaltungen untergebracht werden, da die mögliche Transistordichte und Miniaturisierung durch
bessere Fertigungstechniken immer weiter erhöht wurde. Das Ergebnis dieser Entwicklungen sind
neben diversen Elektrogeräten mit minimierter Anzahl an diskreten (einzelnen) Transistoren
auch die heutigen Mikroprozessoren, die unter anderem die Basis der PCs darstellen. Ohne
diese programmierbaren hochintegrierten Transistorschaltungen, wäre der Computer für
Jedermann und auch die damit verbundene Gesellschaftsentwicklung undenkbar. Die Anzahl
der Transistoren in Prozessoren steigt ständig und verdoppelt sich in konstanten
Zeitabständen ungefähr, so dass der Pentium II-Prozessor schon 7,5 Millionen Transistoren
auf einem Chip enthielt, während der erste Intel-Prozessor 4004 im Jahre 1971 noch mit
2300 Transistoren rechnete. Auch wird die Schaltgeschwindigkeit (Taktung) der meist auf FETs
basierten Prozessoren immer höher und die Computer damit immer schneller.
3) Physikalische Grundlagen zum Verständnis des Bipolartransistors
3.1) Stromleitung in Halbleitern: Eigenleitung/Störstellenleitung
 Die gebräuchlichsten Halbleiter sind Silizium und Germanium, ihre Atome besitzen vier
Außenelektronen. In der natürlichen Kristallstruktur dieser Stoffe bindet sich jedes
der vier Außenelektronen eines Atoms mit einem Außenelektron des nächsten Nachbaratoms
(Abb 3.1). Alle Elektronen sind im Kristallgitter gebunden, und der Halbleiter leitet
nicht. Bei Erwärmung des Halbleiters (auch schon bei Zimmertemperatur) oder Zufuhr von
Photonen geeigneter Frequenz steigt die innere Energie des Materials an und Elektronen
können sich aus der Bindung losreißen und werden frei. Je heißer der Kristall wird oder
je mehr er Licht ausreichend hoher Freqenzen ausgesetzt wird, desto mehr wird verliert
damit er die Eigenschaften eines Isolators und nimmt die Eigenschaften eines Leiters an,
da freie Ladungsträgerpaare generiert werden, indem sich Elektronen losreißen und jetzt
am Atom eine negative kernladungsausgleichende Ladung fehlt.
Die gebräuchlichsten Halbleiter sind Silizium und Germanium, ihre Atome besitzen vier
Außenelektronen. In der natürlichen Kristallstruktur dieser Stoffe bindet sich jedes
der vier Außenelektronen eines Atoms mit einem Außenelektron des nächsten Nachbaratoms
(Abb 3.1). Alle Elektronen sind im Kristallgitter gebunden, und der Halbleiter leitet
nicht. Bei Erwärmung des Halbleiters (auch schon bei Zimmertemperatur) oder Zufuhr von
Photonen geeigneter Frequenz steigt die innere Energie des Materials an und Elektronen
können sich aus der Bindung losreißen und werden frei. Je heißer der Kristall wird oder
je mehr er Licht ausreichend hoher Freqenzen ausgesetzt wird, desto mehr wird verliert
damit er die Eigenschaften eines Isolators und nimmt die Eigenschaften eines Leiters an,
da freie Ladungsträgerpaare generiert werden, indem sich Elektronen losreißen und jetzt
am Atom eine negative kernladungsausgleichende Ladung fehlt.
 Daher wurde effektiv auch
noch eine positive Ladung, Loch genannt, generiert und man spricht vom Paar. Diese
sogenannte Eigenleitung ist aber für den Transistor nicht von Nutzen. Es gibt nämlich
noch eine zweite Möglichkeit, Halbleiter leitend zu machen: Die Einbringung von
Fremdatomen in den Kristall (Dotierung). Indem die Siliziumschmelze mit drei- oder
fünfwertigen Atomen gezielt verschmutzt wird, wobei ein übliches Verhältnis von
Grundstoff zu Fremdstoff im resultierenden Kristall 1:1000000 ist, wird das Gefüge
der gebundenen Elektronen im Kristallgitter gestört. Bei Einbringung von z.B. Antimon,
Phosphor oder Arsen (fünfwertig) kann ein Elektron des Fremdatoms nicht gebunden werden,
es ist somit beweglich und der Kristall leitfähig, man spricht von n-Leitendem
Halbleitermaterial mit Fähigkeit zur Störstellenleitung. Bei Verschmutzung mit
beispielsweise Indium, Gallium oder Aluminium (dreiwertig) fehlt ein Elektron im
Bindungsgefüge.
Daher wurde effektiv auch
noch eine positive Ladung, Loch genannt, generiert und man spricht vom Paar. Diese
sogenannte Eigenleitung ist aber für den Transistor nicht von Nutzen. Es gibt nämlich
noch eine zweite Möglichkeit, Halbleiter leitend zu machen: Die Einbringung von
Fremdatomen in den Kristall (Dotierung). Indem die Siliziumschmelze mit drei- oder
fünfwertigen Atomen gezielt verschmutzt wird, wobei ein übliches Verhältnis von
Grundstoff zu Fremdstoff im resultierenden Kristall 1:1000000 ist, wird das Gefüge
der gebundenen Elektronen im Kristallgitter gestört. Bei Einbringung von z.B. Antimon,
Phosphor oder Arsen (fünfwertig) kann ein Elektron des Fremdatoms nicht gebunden werden,
es ist somit beweglich und der Kristall leitfähig, man spricht von n-Leitendem
Halbleitermaterial mit Fähigkeit zur Störstellenleitung. Bei Verschmutzung mit
beispielsweise Indium, Gallium oder Aluminium (dreiwertig) fehlt ein Elektron im
Bindungsgefüge.  Der freie Platz kann als virtueller positiver Ladungsträger (Loch)
durch den Kristall weiterwandern, indem er von einem Elektron besetzt wird, an
dessen Herkunftsort dann die Fehlstelle ist (=>Leitfähigkeit). Man spricht vom p-leitenden
Halbleiter, der zur Störstellenleitung fähig ist. Im n-Halbleiter nennt man die Elektronen
als hauptsächliche Träger eines Stromes Majoritätsträger, die Löcher Minoritätsträger.
Im p-Kristall ist das ganze umgekehrt. Minoritätsträger werden für gewöhnlich
von Majoritätsträgern neutralisiert, falls sie einmal durch thermische Lösung
eines Elektronen von einem Atom entstehen.
Der freie Platz kann als virtueller positiver Ladungsträger (Loch)
durch den Kristall weiterwandern, indem er von einem Elektron besetzt wird, an
dessen Herkunftsort dann die Fehlstelle ist (=>Leitfähigkeit). Man spricht vom p-leitenden
Halbleiter, der zur Störstellenleitung fähig ist. Im n-Halbleiter nennt man die Elektronen
als hauptsächliche Träger eines Stromes Majoritätsträger, die Löcher Minoritätsträger.
Im p-Kristall ist das ganze umgekehrt. Minoritätsträger werden für gewöhnlich
von Majoritätsträgern neutralisiert, falls sie einmal durch thermische Lösung
eines Elektronen von einem Atom entstehen.
3.2) Der P-N-Übergang; die Halbleiterdiode und ihre Funktion
Nicht die grundsätzliche Leitfähigkeit eines einzelnen p- oder n-Kristalls ist besonders
interessant (Metalle sind viel bessere Leiter), sondern, wie sich Halbleiterschichten aus
einem p- und unmittelbar angrenzendem n-Bereich, sogenannte p-n-Übergänge, verhalten.
In der Übergangszone rekombinieren (vereinigen sich) die freien Ladungsträger, d.h.
Elektronen besetzen die Löcher.  Dadurch verringert sich ihre Anzahl in dieser Zone, da
die Störungen im Bindungsgefüge der Elektronen (s.o.) behoben werden. Jedoch fehlen dann
in der n-Zone Elektronen bzw. in der p-Zone Löcher, wodurch die n-Zone positiv und die
p-Zone negativ geladen wird (Entstehung v. Raumladungszonen i. SperrschichtbeŁ- reich,
Abb. 3.4). Das so entstandene elektrische Feld wirkt der Diffusion der Ladungsträger
in die andere Schicht und so der Rekombination entgegen, daher nennt man
die entstandene Spannung zwischen n- und p-Schicht Antidiffusionsspannung. Die Grenzschicht
ist bei Eintreten eines Gleichgewichtes zwischen dem Diffusionsbestreben und der entgegenwirkenden
Spannung durch Verarmung an freien Ladungsträgern, die einen normalen kettenreaktionsartigen
Ladungsträgertransport verhindert, bereits hochohmig. Was passiert aber nun, wenn wir an
unsere Schichten eine Spannung anlegen? Wenn wir an die n-Schicht den Pluspol legen und
an die p-Schicht den Minuspol, werden die vorhandenen Majoritätsträger an die Kontakte
und von der Grenzschicht weg gezogen und damit ist das ganze System ein hochohmiger
Isolator. Die Majoritätsträger kommen also aufgrund der Polung für eine weitere
Stromleitung nicht mehr in Frage.
Dadurch verringert sich ihre Anzahl in dieser Zone, da
die Störungen im Bindungsgefüge der Elektronen (s.o.) behoben werden. Jedoch fehlen dann
in der n-Zone Elektronen bzw. in der p-Zone Löcher, wodurch die n-Zone positiv und die
p-Zone negativ geladen wird (Entstehung v. Raumladungszonen i. SperrschichtbeŁ- reich,
Abb. 3.4). Das so entstandene elektrische Feld wirkt der Diffusion der Ladungsträger
in die andere Schicht und so der Rekombination entgegen, daher nennt man
die entstandene Spannung zwischen n- und p-Schicht Antidiffusionsspannung. Die Grenzschicht
ist bei Eintreten eines Gleichgewichtes zwischen dem Diffusionsbestreben und der entgegenwirkenden
Spannung durch Verarmung an freien Ladungsträgern, die einen normalen kettenreaktionsartigen
Ladungsträgertransport verhindert, bereits hochohmig. Was passiert aber nun, wenn wir an
unsere Schichten eine Spannung anlegen? Wenn wir an die n-Schicht den Pluspol legen und
an die p-Schicht den Minuspol, werden die vorhandenen Majoritätsträger an die Kontakte
und von der Grenzschicht weg gezogen und damit ist das ganze System ein hochohmiger
Isolator. Die Majoritätsträger kommen also aufgrund der Polung für eine weitere
Stromleitung nicht mehr in Frage.  Und zudem wirkt die Tatsache, dass in dem Kristall
(s.o.) keine kettenreaktionsartige Bewegung der Ladungsträger mehr möglich ist, einem
Strom von Minoritätsträgern entgegen. Kann doch einmal ein Minoritätsträger ins System
eindringen, so wird die schon vorhandene, im p-Raum negative und im n-Raum positive
Raumladung noch verstärkt, da der eingedrungene Ladungsträger sich nicht oder nur ganz
schwer durch den geordneten Kristall bewegen kann
und damit zuerst einmal eine quasi-statische Ladung ist. Dies verhindert einen
weiteren Einstrom von Minoritätsträgern. Es fließt nur noch ein minimaler Strom,
der durch zufällig (d.h. thermisch bedingt) in den Zonen irgendwo entstehende
Minoritätsträger getragen wird, die eine Eigenleitung des Kristalls hervorrufen.
Polen wir unsere Spannungsquelle jedoch um (Pluspol an der p-Schicht, Minuspol an
der n-Schicht), werden die Ladungsträger in Richtung der verarmten Sperrschicht
gedrückt, die vorher vorhandenen Raumladungszonen bauen sich ab. An der Sperrschicht
können Elektronen mit Löchern rekombinieren. Die n-Schicht bekommt Elektronen von der
Stromquelle nachgeliefert, während aus der p-Schicht dauernd welche abgesaugt, oder,
anders ausgedrückt, Löcher vom Pluspol nachgeliefert werden. Damit hat ein Stromfluss
Und zudem wirkt die Tatsache, dass in dem Kristall
(s.o.) keine kettenreaktionsartige Bewegung der Ladungsträger mehr möglich ist, einem
Strom von Minoritätsträgern entgegen. Kann doch einmal ein Minoritätsträger ins System
eindringen, so wird die schon vorhandene, im p-Raum negative und im n-Raum positive
Raumladung noch verstärkt, da der eingedrungene Ladungsträger sich nicht oder nur ganz
schwer durch den geordneten Kristall bewegen kann
und damit zuerst einmal eine quasi-statische Ladung ist. Dies verhindert einen
weiteren Einstrom von Minoritätsträgern. Es fließt nur noch ein minimaler Strom,
der durch zufällig (d.h. thermisch bedingt) in den Zonen irgendwo entstehende
Minoritätsträger getragen wird, die eine Eigenleitung des Kristalls hervorrufen.
Polen wir unsere Spannungsquelle jedoch um (Pluspol an der p-Schicht, Minuspol an
der n-Schicht), werden die Ladungsträger in Richtung der verarmten Sperrschicht
gedrückt, die vorher vorhandenen Raumladungszonen bauen sich ab. An der Sperrschicht
können Elektronen mit Löchern rekombinieren. Die n-Schicht bekommt Elektronen von der
Stromquelle nachgeliefert, während aus der p-Schicht dauernd welche abgesaugt, oder,
anders ausgedrückt, Löcher vom Pluspol nachgeliefert werden. Damit hat ein Stromfluss
 durch den Übergang eingesetzt, unser System ist leitend. Jedoch fällt an ihm bei
Durchfluss von Elektronen der Betrag einer Antidiffusionsspannung ab, die von den
Elektronen unter dem Energieverlust e*Uad durchlaufen werden muss. Diese
kommt daher, dass die kräftige Bewegung der Majoritätsträger zu den Polen der
Spannungsquelle und damit zur anderen Zone zu einem Diffusionsschwanz (in Abb.
3.6 als hellere Ladungsträger dargestellt) von Minoritätsträgern in den Zonen
und damit wiederum zu Aufladung von Räumen führt.
durch den Übergang eingesetzt, unser System ist leitend. Jedoch fällt an ihm bei
Durchfluss von Elektronen der Betrag einer Antidiffusionsspannung ab, die von den
Elektronen unter dem Energieverlust e*Uad durchlaufen werden muss. Diese
kommt daher, dass die kräftige Bewegung der Majoritätsträger zu den Polen der
Spannungsquelle und damit zur anderen Zone zu einem Diffusionsschwanz (in Abb.
3.6 als hellere Ladungsträger dargestellt) von Minoritätsträgern in den Zonen
und damit wiederum zu Aufladung von Räumen führt.
Einen p-n-Übergang
mit Anschlussdrähten an der n- und p-Schicht nennt man Halbleiterdiode. Sie hat die Funktion eines Gleichrichters, d.h., sie lässt Strom nur in einer Richtung passieren. Während dem Umschaltvorgang muss die Übergangszone jeweils mit Ladungsträgern gefüllt oder von ihnen geleert werden. Dieser Verzögerungseffekt hat kapazitive Wirkung und führt dazu, dass für Wechselströme bestimmter Frequenzen nur bestimmte Diodentypen zur Gleichrichtung einsetzbar sind.
3.3) Der Aufbau und die Funktionsweise des Bipolartransistors
 Nun stellt sich vielleicht die Frage, warum ich so lange über p-n-Übergänge, also Dioden,
referiert habe, obwohl diese Facharbeit Transistoren zum Thema
hat. Die Antwort ist einfach: Transistoren nutzen ebenfalls die Effekte
an p-n-Übergängen aus und damit ist mittels der oben erläuterten Erkenntnisse über Halbleiter
auch eine Betrachtung des Bipolartransistors nicht mehr so schwer, soweit sie in unserem Rahmen
möglich ist. Bipolartransistoren
bestehen aus einem Sandwich von Halbleitermaterial verschiedener Dotierung, wobei das Brot
im npn-Transistor, an dem ich die Transistorfunktion erklären will, aus Material vom n-Typ
und der dünne Aufstrich aus Material vom p-Typ besteht. Die äußeren Schichten heißen
Kollektor (C) und Emitter (E) und sind dicker als die p-Schicht, die Basis (B) genannt wird;
jede Schicht besitzt einen Anschluss, der aus dem Transistorgehäuse geführt ist. Wird an die
npn-Strecke vom Kollektor zum Emitter eine Spannung (Pluspol am Kollektor) angelegt, stellt
sich heraus, dass kein Strom durch den npn-Übergang fließt. Das überrascht auch nicht,
zumal am B-C-Übergang die freien Majoritätsträger durch die anliegende Spannung von der
Grenzschicht weggedrängt werden und
so eine hochohmige Sperrschicht (mit starken Bindungen s.o.) entsteht, die Ladungsträger
nur schlecht durchdringen können.
Nun stellt sich vielleicht die Frage, warum ich so lange über p-n-Übergänge, also Dioden,
referiert habe, obwohl diese Facharbeit Transistoren zum Thema
hat. Die Antwort ist einfach: Transistoren nutzen ebenfalls die Effekte
an p-n-Übergängen aus und damit ist mittels der oben erläuterten Erkenntnisse über Halbleiter
auch eine Betrachtung des Bipolartransistors nicht mehr so schwer, soweit sie in unserem Rahmen
möglich ist. Bipolartransistoren
bestehen aus einem Sandwich von Halbleitermaterial verschiedener Dotierung, wobei das Brot
im npn-Transistor, an dem ich die Transistorfunktion erklären will, aus Material vom n-Typ
und der dünne Aufstrich aus Material vom p-Typ besteht. Die äußeren Schichten heißen
Kollektor (C) und Emitter (E) und sind dicker als die p-Schicht, die Basis (B) genannt wird;
jede Schicht besitzt einen Anschluss, der aus dem Transistorgehäuse geführt ist. Wird an die
npn-Strecke vom Kollektor zum Emitter eine Spannung (Pluspol am Kollektor) angelegt, stellt
sich heraus, dass kein Strom durch den npn-Übergang fließt. Das überrascht auch nicht,
zumal am B-C-Übergang die freien Majoritätsträger durch die anliegende Spannung von der
Grenzschicht weggedrängt werden und
so eine hochohmige Sperrschicht (mit starken Bindungen s.o.) entsteht, die Ladungsträger
nur schlecht durchdringen können. 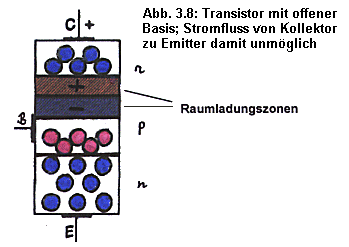 Eine eventuelle Diffusion
von Elektronen in die Basis durch die bei gegebener Polung leitfähige E-B-Sperrschicht
wird dadurch gestoppt, dass in die Basis eindringende Elektronen durch die Sperrschicht
schlecht fließen können, sich die Basis bei Eindringen von schon wenigen Elektronen also
negativ auflädt und dies eine weitere Elektronenbewegung ganz verhindert. Wen man jedoch
an die Basis gegen den Emitter eine weitere positive Spannung Ube anlegt, die
kleiner als die zwischen Kollektor und Emitter und größer als die Antidiffusionsspannung
der B-E-Diode von größenordungnsmäßig 0,7V ist, schafft man es, diese statische Situation
zu lockern. In die Basis kommen wieder positive Ladungsträger, die zum Emitter hin fließen,
und entgegengesetzt kommen aus der Emitterelektrode noch viel mehr Elektronen heraus,
die sich zur Basis bewegen (der Emitter ist stärker dotiert, damit tragen die n-Ladungsträger
aus ihm den Strom in der B-E-Übergangszone hauptsächlich, weil sich aus der schwächer dotierten
Basis auch nur weniger Löcher gleichzeitig zum Emitter bewegen können). Ein Stromfluss
hauptsächlich negativer Ladungsträger hat eingesetzt, da die Basis Elektronen nun nicht
mehr abstößt (die angelegte Spannung hebt die Wirkung der Raumladung auf), und mit ihm
bilden sich am B-E-Übergang die oben (Kapitel p-n-Übergang) genannten Diffusionsschwänze,
wobei der Schwanz der hauptsächlich fließenden Emitterelektronen größer ist. Da die Basis
nur sehr dünn ist, reicht der Diffusionsschwanz dieser Elektronen bis in die zweite
Transistorsperrschicht hinein.
Eine eventuelle Diffusion
von Elektronen in die Basis durch die bei gegebener Polung leitfähige E-B-Sperrschicht
wird dadurch gestoppt, dass in die Basis eindringende Elektronen durch die Sperrschicht
schlecht fließen können, sich die Basis bei Eindringen von schon wenigen Elektronen also
negativ auflädt und dies eine weitere Elektronenbewegung ganz verhindert. Wen man jedoch
an die Basis gegen den Emitter eine weitere positive Spannung Ube anlegt, die
kleiner als die zwischen Kollektor und Emitter und größer als die Antidiffusionsspannung
der B-E-Diode von größenordungnsmäßig 0,7V ist, schafft man es, diese statische Situation
zu lockern. In die Basis kommen wieder positive Ladungsträger, die zum Emitter hin fließen,
und entgegengesetzt kommen aus der Emitterelektrode noch viel mehr Elektronen heraus,
die sich zur Basis bewegen (der Emitter ist stärker dotiert, damit tragen die n-Ladungsträger
aus ihm den Strom in der B-E-Übergangszone hauptsächlich, weil sich aus der schwächer dotierten
Basis auch nur weniger Löcher gleichzeitig zum Emitter bewegen können). Ein Stromfluss
hauptsächlich negativer Ladungsträger hat eingesetzt, da die Basis Elektronen nun nicht
mehr abstößt (die angelegte Spannung hebt die Wirkung der Raumladung auf), und mit ihm
bilden sich am B-E-Übergang die oben (Kapitel p-n-Übergang) genannten Diffusionsschwänze,
wobei der Schwanz der hauptsächlich fließenden Emitterelektronen größer ist. Da die Basis
nur sehr dünn ist, reicht der Diffusionsschwanz dieser Elektronen bis in die zweite
Transistorsperrschicht hinein.  Das heißt, man hat es geschafft, einige Minoritätsträger
(Elektronen) in die p-Basis zu injizieren, die auch meist ohne zu rekombinieren (die Basis
ist dünn und eher schwach dotiert, enthält damit nur wenige Löcher zur Rekombination)
in den Bereich der B-C-Sperrschicht gelangen.ĀDie Ladungsträger werden vom E-Feld des
positiv vorgespannten Kollektoranschlusses erfasst, diffundieren weiter in den Kollektor
und schließlich kommen Elektronen aus dessen Anschlussdraht heraus, statt aus dem
Basisanschluss herauszufließen. Für die aus dem Kollektor herausfließenden Elektronen
liefert die dort angeschlossene Stromquelle wieder entsprechend Elektronen in den
Emitter nach. Daher fließt im Kollektorstromkreis jetzt ein Strom, und er ist deutlich
größer als der Basisstrom, weil die Basis nur wenige Elektronen durch Rekombination mit
aus dem Basisanschluss gekommenen Löchern abzieht; dieses Phänomen nennt man Stromverstärkung.
Vorraussetzung für einen Kollektorstrom ist natürlich, dass eine genügend hohe Spannung
Uce anliegt. Wenn Uce<Ube ist, so heißt das, dass die
B-C-Diode nicht mehr in Sperrrichtung betrieben wird, und damit sehen die in die Basis
injizierten Minoritätsträger auch keinen so großen Anlass mehr, die B-C-Sperrschicht in
Sperrrichtung zum Kollektor hin zu überschreiten, aber dazu noch mehr bei den Kennlinien.
Das heißt, man hat es geschafft, einige Minoritätsträger
(Elektronen) in die p-Basis zu injizieren, die auch meist ohne zu rekombinieren (die Basis
ist dünn und eher schwach dotiert, enthält damit nur wenige Löcher zur Rekombination)
in den Bereich der B-C-Sperrschicht gelangen.ĀDie Ladungsträger werden vom E-Feld des
positiv vorgespannten Kollektoranschlusses erfasst, diffundieren weiter in den Kollektor
und schließlich kommen Elektronen aus dessen Anschlussdraht heraus, statt aus dem
Basisanschluss herauszufließen. Für die aus dem Kollektor herausfließenden Elektronen
liefert die dort angeschlossene Stromquelle wieder entsprechend Elektronen in den
Emitter nach. Daher fließt im Kollektorstromkreis jetzt ein Strom, und er ist deutlich
größer als der Basisstrom, weil die Basis nur wenige Elektronen durch Rekombination mit
aus dem Basisanschluss gekommenen Löchern abzieht; dieses Phänomen nennt man Stromverstärkung.
Vorraussetzung für einen Kollektorstrom ist natürlich, dass eine genügend hohe Spannung
Uce anliegt. Wenn Uce<Ube ist, so heißt das, dass die
B-C-Diode nicht mehr in Sperrrichtung betrieben wird, und damit sehen die in die Basis
injizierten Minoritätsträger auch keinen so großen Anlass mehr, die B-C-Sperrschicht in
Sperrrichtung zum Kollektor hin zu überschreiten, aber dazu noch mehr bei den Kennlinien.
Durch diese stromverstärkenden Funktionsweisen wird eine Verstärkeranwendung
des Transistors ermöglicht. Jedoch ist die Verstärkung aufgrund der kapazitiven Effekte
in den p-n-Übergängen (z.B. müssen noch alle Elektronen aus der
Basis herausfließen, wenn der Transistor in den Sperrzustand übergeht) nur in bestimmten,
vom jeweiligen Transistormodell abhängigen Frequenzbereichen nutzbar.
 Außer diesem Einsatz als
Verstärker ist noch die Schlaltanwendung bekannt. Sie nutzt nur die Zustände "Basisstrom
fließt => Kollektor-Emitter-Strecke offen" und "Basisstrom fließt nicht => Kollektor-Emitter-Strecke
zu". Da die Öffnung der Kollektor-Emitter-Strecke jedoch mit höher werdender Basisleistung
Ube*Ibe langsam und nicht sprunghaft vom Zustand aus auf den Zustand
ein ansteigt, muss man sich eventuell noch eine Schaltung um den Transistor herum einfallen
lassen, die den Bereich des Umkippens von 0 auf 1 möglichst gering macht und möglichst davor
den Zustand völlig aus und danach völlig ein erzeugt, sowie den Umkipppunkt nach den gegebenen
Anforderungen definiert. Auch bei dieser Nutzung des Transistors sind natürlich wie in der
Verstärkeranwendung nur begrenzte Schaltfrequenzen möglich.
Außer diesem Einsatz als
Verstärker ist noch die Schlaltanwendung bekannt. Sie nutzt nur die Zustände "Basisstrom
fließt => Kollektor-Emitter-Strecke offen" und "Basisstrom fließt nicht => Kollektor-Emitter-Strecke
zu". Da die Öffnung der Kollektor-Emitter-Strecke jedoch mit höher werdender Basisleistung
Ube*Ibe langsam und nicht sprunghaft vom Zustand aus auf den Zustand
ein ansteigt, muss man sich eventuell noch eine Schaltung um den Transistor herum einfallen
lassen, die den Bereich des Umkippens von 0 auf 1 möglichst gering macht und möglichst davor
den Zustand völlig aus und danach völlig ein erzeugt, sowie den Umkipppunkt nach den gegebenen
Anforderungen definiert. Auch bei dieser Nutzung des Transistors sind natürlich wie in der
Verstärkeranwendung nur begrenzte Schaltfrequenzen möglich.
Nun noch ein paar Worte zur Dotierung im Alltag. Wie schon besprochen, muss der Emitter recht
stark und die Basis schwach dotiert sein. Jedoch muss auch der Kollektor einen ganz bestimmten
Dotierungsgrad besitzen, und zwar einen geringeren als die Basis, um einige unerwünschte
Effekte am Transistor (siehe Kennlinienbetrachtung: Early-Effekt und Durchgriff) zu verhindern.
Die Hochfrequenzeigenschaften können ebenfalls mittels Dotierung gesteuert werden. Man hat
es in den nun im HF-Bereich dominierenden Drifttransistorenerreicht, in der Basis durch
inhomogene Dotierung ein E-Feld zu erzeugen, das die Elektronen im Betrieb zusätzlich von
der Basis zum Kollektor hin beschleunigt und damit die Zeit ihres Verbleibes in der Basis und
den hierdurch verursachten kapazitiven Effekt verringert. Dies funktioniert im vereinfachten
Prinzip folgendermaßen: Indem man den an den Emitter angrenzenden Bereich stärker p-dotiert,
stellt sich eine Löcherdiffusion in den an den Kollektor angrenzende Bereiche ein, da die Natur
die Konzentration freier Ladungsträger ausgleichen möchte. Daher sind aber die Basisgebiete
nicht mehr neutral, in der Zone am Emitter fehlen die wegdiffundierten positiven Löcher, in der
Zone am Kollektor sind zu viele, es bildet sich ein E-Feld zwischen den entstandenen
Ladungszonen aus, das weiterer Diffusion entgegenwirkt. In die Basis im Betrieb eindringende
Elektronen werden also in den zu positiven an den Kollektor angrenzenden Bereich der Basis
gedrängt. Die genannten Felder überlagern sich im realen Betrieb natürlich wieder mit anderen
Feldern. Trotzdem funktioniert dieses Prinzip, wie man an den hohen Höchstfrequenzen moderner
Transistoren erkennt.

|
Der pnp-Transistor funktioniert im Grunde gleich wie der npn-Typ, nur dass in ihm Löcher in den
Emitter hinein fließen und aus der Basis sowie dem Kollektor herauskommen, weil alle Gebiete,
wie der Name schon andeutet, umgekehrt wie im npn-Typ dotiert sind. Die beiden am Transistor
im Flussbetrieb angeschlossenen Stromquellen müssen also ebenfalls umgepolt sein.
|
3.4) Unipolare Feldeffekt-Transistoren und ihre Funktionsweise; Grund für die Namen unipolar / bipolar
Der Bau eines Feldeffekttransistors war 1945 das eigentliche Ziel Shockleys gewesen, und seitdem man es ungefähr 20 Jahre später das erste mal schaffte, sie zu produzieren, hat ihre Bedeutung ständig zugenommen; in einigen Bereichen haben sie die althergebrachten Bipolartransistoren verdrängt. Daher möchte ich, wenn auch die komplette Darstellung der vielen verschiedenen bis jetzt entwickelten Bauformen den Rahmen sprengen würde, kurz die relativ einfach zu erfassende Funktion dreier Grundtypen zu beschreiben. Der FET
besitzt grundätzlich drei Elektroden: Source (S, entspricht in etwa dem Emitter), Gate (G, entspricht in etwa der Basis) und Drain (D, entspricht ungefähr
dem Kollektor). Das Gate liegt elektrisch über eine sperrgepolte Diode oder eine Isolatorschicht isoliert vom Kristall so zwischen dem Drain- und Source-Bereich, dass ein von ihm ausgehendes E-Feld in der Lage ist, Ladungsträger von den Drain- und Source-Elektroden weg oder zu ihnen hin zu drängen und damit einen leitenden Kanal zwischen Drain und Source zu schaffen oder diese von den Ladungsträgern zu isolieren und damit einen Stromfluss von Drain zu Source zu unterbinden, wobei die Ansteuerung über das isolierte Gate fast leistungslos, d.h. bei anliegender Spannung ohne merkenswerten Strom erfolgt. Der Grundzustand des FETs ist je nach Bauart ohne angelegte Gatespannung entweder recht leitend (Verarmungstyp) oder nicht leitend (Anreicherungstyp).
Man nennt den FET auch Unipolartransistor, da in der Zone, in der der zu steuernde Strom gesteuert wird, ein Ladungsträgertyp den Strom trägt, während im Bipolartransistor drei Dotierungstypen vorhanden sind und Ströme von verschiedenen Ladungsträgern getragen werden (z.B. Einstrom von Löchern aus der Basis in den Emitter beim npn-Transistor). Den FET kann man recht gut mit verwechseltem Source- und Drainanschluss betreiben, da er einen oft ziemlich symmetrischen Aufbau, d.h. Drain und Source sind gleich dotiert, breit, etc., zeigt.
Jetzt aber zu den Bauarten der FETs:
Grundvorstelllung des FETs sei ein quaderförmiger
Kristall von relativ geringer Höhe (Dicke) und quadratischem Grundriss.
Das entspricht u.U. nicht der Fertigung, reicht aber für eine Modellvorstellung
von der Funktion aus.
- Sperrschicht-FET:
(junction FET / JFET)
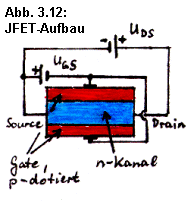

|
Den JFET möchte ich am Beispiel des n-Kanal-Typs erläutern. Dieser Transistor ist im Prinzip ein n-dotierter Kristall, an
dem auf der einen Seitenfläche die Drain-, und gegenüber die Source-Elektrode
liegt, wobei man auf der Drainseite den Pluspol des zu steuernden Stromkreises
und an der Source den Minuspol anschließt. Auf der Ober- und Unterseite ist
der Halbleiter an der Oberfläche p-dotiert, und an diesen zwei Flächen ist
das Gate angeschlossen. Da zwischen Source und Drain kein p-n-Übergang liegt,
kann im Grundzustand, d.h. bei offenem=spannungslosem Gateanschluss, Strom
fließen. Wird jedoch eine negative Spannung gegen Source an das Gate gelegt,
verarmt der Bereich des p-n-Übergangs (Diode in Sperrrichtung) zwischen
Gate und dem n-Kristall an Ladungsträgern und der Querschnitt, in dem noch
Ladungsträger vorhanden sind wird enger. Die Verarmung findet dabei hauptsächlich
im n-Kristall statt, da das Gate stärker dotiert ist (diesen Effekt an gesperrten
Dioden kann man mittels quantitativ-rechnerischer Betrachtung nachweisen).
Schließich sperrt der JFET, wenn die Gatespannung negativ genug ist und der Kanal damit absolut dicht. Das Gate
gegenüber der Source positiv vorzuspannen ist bei diesem Transistortyp unüblich,
da man einen Gatestrom verursachen würde. Das Gate muss gegenüber beiden
anderen Elektroden negativ vorgespannt sein, was man durch die negative
Vorspannung gegenüber Source bei angegebener Polung erreicht.
Das p-Kanal Pendant ist umgekehrt dotiert und verlangt daher am Gate
eine positive Spannung zum Sperren und auch eine umgekehrte D-S-Spannung,
hier ist eine negative Vorspannung des Gates unüblich.
Statt der normalen Gatediode kann im Übrigen auch ein auf den Kristall aufgesetzter Metallkontakt verwendet
werden, da ein Übergang von gewissen ausgewählten Metallen auf eine dotierte
Halbleiterstruktur (Schottky-Diode) ähnliche gleichrichtende Charakteristiken
wie ein p-n-Übergang zeigt. Der Metallkontakt spielt dabei die Rolle des
entgegengesetzt zum Kristall dotierten Halbleiters, die Funktion des FETs
ändert sich also nicht grundlegend. Ein so konzipierter FET heißt auch MESFET
(metal-semiconductor field effect transistor)
Der Sperrschicht-FET ist ein
Verarmungstyp, da in ihm das Gate primär die Funktion hat, die Ladungsträger
wegzudrängen und den FET, dessen leitender Bereich dann an Ladungsträgern
verarmt ist, zu sperren.
|
-MOSFET als Isolierschicht-FET:
(insulated gate field effect
transistor / IGFET)

|
Bei den IGFETs (zu ihnen gehören MISFETs=metal-insulator-semiconductor
field effect transistors und die dünnschichtigen TFTs=thin-film transistors)
ist das Gate vom Rest des Transistors, wie die englische Bezeichnung
schon sagt, elektrisch isoliert. Am üblichsten ist als Isoliermaterial Siliziumdioxid.
Dieses findet sich in den MOSFETs (MOSFET=metal-oxide-semiconductor
field effect transistor). Auch bei den MOSFETs möchte ich die n-Kanal-Typen
erklären, genauso gibt es aber umgekehrt dotierte p-Kanal Typen, der wieder
umgekehrt gepolt werden.
|
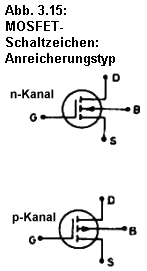

|
-
Anreicherungstyp:
ĀĀĀ
Der MOSFET vom n-Kanal-Anreicherungstyp besteht in der Modellvorstellung
aus einem p-dotierten Kristall, in den auf der Oberseite zwei n-Bereiche
in einigem Abstand hineinragen, deren Dicke ca. die Hälfte der Kristalldicke
ist. Sie sind Source und Drain. Zwischen ihnen ist wiederum der Gateanschluss
auf dem p-Halbleiter, jedoch ist er vom Halbleiter im Gegensatz zum Sperrschichttyp
durch eine Siliziumdioxid-Isolatorschicht getrennt (=>fast leistungslose Spannungsansteuerung). Ihm gegenüber
ist an dem Halbleiter ein sogenannter Basisanschluss (=Substrat-/Bulkanschluss)
montiert. Zwischen Source und Drain kann normalerweise kein Strom fließen,
da ein npn-Übergang vorliegt. Wird aber ein E-Feld mit Richtung vom Gate
zur Basis hin aufgebaut, so werden aus dem Bereich zwischen Source und drain
die Löcher verdrängt und Elektronen dorthingezogen (-> Anreicherungstyp),
weshalb der p-Halbleiter sich zwischen S und D sich in einen n-Halbleiter
umwandelt. Daher kann ein Strom von S zu D fließen. Oft ist der Basisanschluss
mit der Source verbunden, so dass Bedingung für die Leitung eine positive
Spannung von Gate zu Source ist.
|
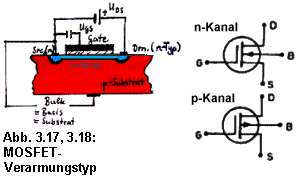
|
-
Verarmungstyp:
Wird auf
die Oberfläche des oben beschriebenen MOSFETs noch eine n-leitende Halbleiterschicht
aufgebracht, so besteht auch bei nicht angelegter Gatespannung eine Leitfähigkeit
zwischen Drain und Source an der Oberfläche. Diese kann durch eine negative
Gatevorspannung (Verdrängung der Elektronen in der n-Schicht) wiederum nichtleitend
gemacht werden. Die andere Seite reagiert dabei nicht, sie lässt sich weiterhin
im Anreicherungsmodus durch positive Gatevorspannung gut leitend machen.
Insgesamt wurde also ein Verarmungstyp erzeugt.
|
Neben diesen Feldeffekttransistoren existieren noch, wie ich am Anfang
dieses Kapitels schon angedeutet habe, andere, teils mit obigen verwandte
Bauformen. Beispiele hierfür sind FETs mit extrakurzem Kanal (DMOST , TMOST,
VMOST), der eine kurze Schaltgeschwindigkeit mit sich bringt, GaAs-FETs
für HF-Anwendungen, V-, U- D- und Siemens-Power-MOSFETS für Großsignalanwendung
sowie viele andere mit Spezialfunktionen für Computerspeicher etc..
3.5) Andere Transistortypen
Neben FETs und gewöhnlichen Bipolartransistoren existieren auch noch andere
Arten, für die ich im Folgenden noch einige Beispiele geben will, wenn auch
eine vollständige Aufstellung aufgrund der immer neu entstehenden Entwicklungen
schlecht möglich ist:
-
Hochleistungstransistoren, die eine
interne Zusammenschaltung eines bipolar- und FET-Transistors darstellen
(IGBT=insluated gate bipolar transistor)
und ganz besondere Eigenschaften entwickeln.
-
Unijunction-Transistoren, die im Prinzip aus einem schwach dotierten und
deshalb schlecht leitenden n-Halbleiterstäbchen mit Elektroden am Ende (Basen)
sowie einer aufgesetzten p-Elektrode in der Mitte (Emitter) bestehen, und
nur unter besonderen Bedingungen die Strecke zwischen den Basen freigeben.
-
Phototransistoren, bei denen freie
Ladungsträger in der Basis nicht durch Injektion, sondern durch optische Auslösung
erzeugt werden; damit setzt bei ihnen wie beim Bipolartransistor auch ein
starker Strom zwischen Kollektor und Emitter ein, von dem sich dann auf die
einfallende Lichtintensität schließen lässt.
4) Herstellung von Tranistoren
Dieses Kapitel soll einige Beispiele
für historische
und heutige Herstellungsmethoden für Transistoren geben, wenngleich auch
hier die heute eingesetzte Technik das Fassungsvermögen eines Buches übersteigt.
Ich habe mich vor allem auf Beispiele am Bipolartransistor konzentriert,
an denen man einen Überblick über gebräuchliche Verfahren bekommt; die Fertigung
von FETs verläuft mit den Grundtechniken des zuletzt genannten modernen
Planarverfahrens, die einzigen Unterschiede liegt in anderen Abfolgen von
Produktionsprozessen; ein paar interessante und relevante Unterschied werde
ich nennen.
Bei fast allen Prozessen ist eine außerordentliche Reinhaltung der Herstellungsräume
für ordnungsgemäße Beschaffenheit der Halbleiter erforderlich. Das macht
oft aufwendige Techniken (Reinräume etc.) erforderlich.
Bei der Erstellung dieses Kapitels verlängerte sich die Facharbeit sehr,
ohne dass ich es eigentlich gewollt hätte. Mir ist durchaus bewusst, dass
es in einer Facharbeit wichtig ist, zwischen relevanten und nicht relevanten
Punkten zu unterscheiden, dennoch möchte ich den "unnötigen" Bereich über
historische Herstellungsverfahren so belassen, da er recht interessant ist.
4.1) Gewinnung von reinen Halbleitersubstanzen
Germanium wird z.B. als Nebenprodukt bei der Metallverhüttung und als Flugstaub
von in Großbritannien geförderten Steinkohlesorten gewonnen und kommt als
Germaniumdioxid auf den Markt, Silizium liegt natürlicherweise meist als
Si 2O3 in der Form von Sand vor. In chemischen Reduktionsprozessen
in Spezialöfen werden die Oxide zu den Halbleitern Si bzw. Ge reduziert.
Jedoch enthält der Kristall noch zu viele unerwünschte Verunreinigungen,
und die Kristallstruktur ist noch nicht optimal. Hier nutzt man die Tatsache,
dass die Si- bzw. Ge-Schmelze mehr Fremdatome enthalten kann als ein ausgehärteter
Kristall, schmilzt zuerst einen Anfangsabschnitt des Stabes, und lässt dann
die Schmelzzone längs am Stab entlangwandern. Bei diesem Vorgang fliehen
die Verunreinigungen aus dem abkühlenden Kristallbereich in das geschmolzene
Stück und wandern somit mit dem Schmelzbereich bis ans Ende des Kristalls.
Ist das Verfahren abgeschlossen, muss das Ende verworfen werden, der Rest
ist (zumindest nach mehreren Vorgängen) fast reines Halbleitermaterial.
Was hier so einfach klingt, ist jedoch in der Praxis ein sehr schwieriger
Prozess, weil das Material immer rein gehalten werden muss. Nach der Reinigung
schmilzt man den Halbleiterstab ein, um dann normalerweise unter Zuhilfenahme
eines Impfkristalls nach oben einen Einkristall langsam aus der Schmelze
zu ziehen, wobei sich, während man den Impfkristall nach oben zieht, der
geschmolzene Stoff in langsam erkaltenden Schichten um Kristallstruktur
des Impfkristalles anlagert.
4.2) Ältere Produktionsverfahren für Bipolartransistoren
 Als allererstes Herstellungsverfahren beschrieb Shockley 1951 eine Methode,
bei der man die nötige n-p-n-Struktur direkt beim Ziehen herstellt. Zuerst
gibt man der Halbleiterschmelze für den Kollektor eine eher schwache n-Dotierung
in Form eines geeigneten verunreinigenden Elementes zu, zieht den Kristall
ein Stück aus der Schmelze und überdeckt dann die n-Dotierung durch Einbringung
genügend dreiwertiger Atome, die den Halbleiter im späteren Basisbereich
p-leitend machen. Nun muss schon nach einer geringen
gezogenen Schichtdicke wieder ausreichend fünfwertiges Material zugegeben werden, um den
Emitter mit besonders hoher Dotierung zu erzeugen. Man erhält einen zwiebelförmigen,
oben und unten n-dotierten Kristall, der in der Mitte eine dünne, quer verlaufende
p-Schicht enthält. Nun schneidet man den Kristall längs zur Zugrichtung
in Scheiben und diese schließlich ebenfalls längs zur Zugrichtung in Einzelstücke.
Schließlich werden die Transistoren nach eventuell noch anderen Schritten
in einem Lötvorgang kontaktiert, wobei die Basis erst wieder durch Oberflächenabtastungsmethoden
ausfindig gemacht werden muss. Man beachte, dass für die Kontaktierung von
Halbleiterschichten bei diesem und allen Verfahren solche Metalle oder Metalllegierungen
als Kontakte ausgewählt werden müssen, die mit dem Halbleiter keinen Schottky-Kontakt,
sondern einen Kontakt mit gewöhnlicher ohmscher Übertragungscharakteristik
bilden.
Als allererstes Herstellungsverfahren beschrieb Shockley 1951 eine Methode,
bei der man die nötige n-p-n-Struktur direkt beim Ziehen herstellt. Zuerst
gibt man der Halbleiterschmelze für den Kollektor eine eher schwache n-Dotierung
in Form eines geeigneten verunreinigenden Elementes zu, zieht den Kristall
ein Stück aus der Schmelze und überdeckt dann die n-Dotierung durch Einbringung
genügend dreiwertiger Atome, die den Halbleiter im späteren Basisbereich
p-leitend machen. Nun muss schon nach einer geringen
gezogenen Schichtdicke wieder ausreichend fünfwertiges Material zugegeben werden, um den
Emitter mit besonders hoher Dotierung zu erzeugen. Man erhält einen zwiebelförmigen,
oben und unten n-dotierten Kristall, der in der Mitte eine dünne, quer verlaufende
p-Schicht enthält. Nun schneidet man den Kristall längs zur Zugrichtung
in Scheiben und diese schließlich ebenfalls längs zur Zugrichtung in Einzelstücke.
Schließlich werden die Transistoren nach eventuell noch anderen Schritten
in einem Lötvorgang kontaktiert, wobei die Basis erst wieder durch Oberflächenabtastungsmethoden
ausfindig gemacht werden muss. Man beachte, dass für die Kontaktierung von
Halbleiterschichten bei diesem und allen Verfahren solche Metalle oder Metalllegierungen
als Kontakte ausgewählt werden müssen, die mit dem Halbleiter keinen Schottky-Kontakt,
sondern einen Kontakt mit gewöhnlicher ohmscher Übertragungscharakteristik
bilden.
Inwieweit man damals auch pnp-Transistoren im Ziehverfahren erfolgreich
herstellen konnte, ist mir leider, genauso wie bei einigen unten genannten
Produktionsarten, nicht bekannt; die hier besprochenen Verfahren sind teilweise
schon sehr antiquiert und überholt, weshalb sie in vielen Büchern schon überhaupt
nicht mehr auftauchen. Das macht eine Recherche schwierig.
 Die nächste und auch bedeutendere Bauform war der Legierungstransistor,
dessen Ausgangsmaterial eine dünne, kleine Scheibe (auch Wafer) aus n-Germanium-Kristall
ist. Man setzt auf diese Scheibe auf beiden Seiten Pillen (Pellets) von
Indium und erwärmt die Anordnung auf eine Temperatur, bei der das Indium
schon gut, das Germanium (höherer Schmelzpunkt) aber noch überhaupt nicht
schmilzt. Bei diesem Vorgang gelangen dreiwertige Atome in das Germanium
und dotieren es an den Übergangszonen um, so dass eine pnp-Schichtfolge entsteht.
Schließlich werden die beiden Pillen mit angelötetem Silberdraht und die
Basis meist mit Hilfe eines auf den Kristall gelöteten Metallringes um die
Emitterpille kontaktiert. Auf ähnliche Art kann man einen p-leitenden Germaniumkristall
mittels Arsen oder Antimon zu einem npn-Transistor machen, ebenso können
auch Siliziumtransistoren mit Aluminium als Pillenmaterial hergestellt werden,
allerdings gestaltet sich das aufgrund besonderer Materialeigenschaften
schwieriger.
Die nächste und auch bedeutendere Bauform war der Legierungstransistor,
dessen Ausgangsmaterial eine dünne, kleine Scheibe (auch Wafer) aus n-Germanium-Kristall
ist. Man setzt auf diese Scheibe auf beiden Seiten Pillen (Pellets) von
Indium und erwärmt die Anordnung auf eine Temperatur, bei der das Indium
schon gut, das Germanium (höherer Schmelzpunkt) aber noch überhaupt nicht
schmilzt. Bei diesem Vorgang gelangen dreiwertige Atome in das Germanium
und dotieren es an den Übergangszonen um, so dass eine pnp-Schichtfolge entsteht.
Schließlich werden die beiden Pillen mit angelötetem Silberdraht und die
Basis meist mit Hilfe eines auf den Kristall gelöteten Metallringes um die
Emitterpille kontaktiert. Auf ähnliche Art kann man einen p-leitenden Germaniumkristall
mittels Arsen oder Antimon zu einem npn-Transistor machen, ebenso können
auch Siliziumtransistoren mit Aluminium als Pillenmaterial hergestellt werden,
allerdings gestaltet sich das aufgrund besonderer Materialeigenschaften
schwieriger.
Der Legierungstransistor litt unter Einflüssen von außen, da der Kristall
offenlag und man es nicht schaffte, die Gehäuse entsprechend abzudichten.
Daher war ein kommerzieller Einsatz schlecht möglich. Er konnte Frequenzen
bis zu 7 MHz schalten; wenn die Mittelschicht zusätzlich durch Ätzung dünner
gemacht und statt Pellets eine galvanische Ablagerung von Indium aufgetragen
und evtl. durch Erhitzen einglegiert wurde, erreichten die entstandenen
Randschichttransistoren sogar bis zu 50 MHz maximale Schaltfrequenz.
Etwas später entwickelte man dann die Diffusionstechnik, bei der
man beispielsweise das Halbleitermaterial in einem 1250░ heißen Ofen einem
Dampf mit den Störatomen aussetzt und die Störatome so in den Kristall diffundieren.
Da hierbei deren Konzentration im Halbleiter mit der Diffusionstiefe abnimmt,
war ab diesem Zeitpunkt nun im Prinzip eine Herstellung von Drifttranistoren
möglich.
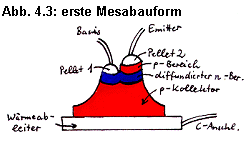 Schon 1956 wurde eine noch andere, ebenfalls mit obigem Diffusionsverfahren verwandte Dotiertechnik
das erste mal genutzt. Dabei legiert man auf einen p-Germaniumkristall zwei
Pellets von entgegengesetzt dotierenden Störstoffen auf. Das ganze wird nun
stark erwärmt, wobei die n-störenden Atome schneller in das an Elektronen
arme p-Germanium diffundieren und eine n-leitende Schicht im gesamten Oberflächenbereich
bilden, bevor die p-Atome zu diffundieren beginnen und auf die n-Zone noch
einmal eine p-Zone setzen; die resultierende Schichtfolge ist also pnp,
am Kristall wird der Kollektor kontaktiert und an den Pillen Basis und Emitter.
Die oberen Schichten des Transistors werden zur Verbesserung der elektrischen
Eigenschaften bis zur Stelle, wo die Pillen sitzen, seitlich weggeätzt (die
von den Pillen entfernten Bereiche erfüllen keine Funktion und stellen unnötigen
kapazitiven Ballast dar), was diesem Transistor das Aussehen eines Tafelbergs,
spanisch "Mesa", gab.
Schon 1956 wurde eine noch andere, ebenfalls mit obigem Diffusionsverfahren verwandte Dotiertechnik
das erste mal genutzt. Dabei legiert man auf einen p-Germaniumkristall zwei
Pellets von entgegengesetzt dotierenden Störstoffen auf. Das ganze wird nun
stark erwärmt, wobei die n-störenden Atome schneller in das an Elektronen
arme p-Germanium diffundieren und eine n-leitende Schicht im gesamten Oberflächenbereich
bilden, bevor die p-Atome zu diffundieren beginnen und auf die n-Zone noch
einmal eine p-Zone setzen; die resultierende Schichtfolge ist also pnp,
am Kristall wird der Kollektor kontaktiert und an den Pillen Basis und Emitter.
Die oberen Schichten des Transistors werden zur Verbesserung der elektrischen
Eigenschaften bis zur Stelle, wo die Pillen sitzen, seitlich weggeätzt (die
von den Pillen entfernten Bereiche erfüllen keine Funktion und stellen unnötigen
kapazitiven Ballast dar), was diesem Transistor das Aussehen eines Tafelbergs,
spanisch "Mesa", gab.
Der endgültige Mesa-Transistor
schließlich wurde tatsächlich im Ofen gefertigt. Um ihn herzustellen setzt
man eine nicht ganz so dünne n-Siliziumscheibe (0,4mm dick) erst an der
Oberseite einem Dampf aus p-Fremdmaterial aus und dann, nachdem man die
Schichten mit einer klein gelochten Lochmaske abgedeckt hat, an derselben
Seite einem Dampf aus n-dotierenden Atomen. Es entsteht eine Struktur von
einer nicht angegriffenen n-Schicht im unteren Bereich (Kollektor), darauf
folgt eine p-Schicht (Basis) und schließlich eindiffundierte n-Bereiche
an den Stellen, wo die Lochmaske durchlässig war. Jeder obenliegende n-Bereich stellt einen Emitter für einen Transistor
dar; die Transistoren werden getrennt. Die Kontaktierung erfolgt am Emitter
durch Einlegieren eines Goldfilms als Anschluss und im Basisbereich auf
selbige Weise mit Aluminium. An der Unterseite findet sich der Kollektoranschluss,
der gleichzeitig als Wärmeableiter konzipiert ist. Wenn eine konventionelle
Kontaktierung bei kleinen Bauformen nicht mehr möglich ist, muss man zum
Thermokompressionsverfahren greifen, in dem man einen feinen Golddraht über
der Kontaktstelle platziert und mittels einer Spitze bei etwa 300░C in Schutzgas
andrückt. Neben solchen npn-Transistoren kann man auf ähnliche Weise auch
eine pnp-Bauform erzeugen. Auch hier werden die Transistoren wie beim älteren
Typ zu einer Mesa-Form geätzt.
Jeder obenliegende n-Bereich stellt einen Emitter für einen Transistor
dar; die Transistoren werden getrennt. Die Kontaktierung erfolgt am Emitter
durch Einlegieren eines Goldfilms als Anschluss und im Basisbereich auf
selbige Weise mit Aluminium. An der Unterseite findet sich der Kollektoranschluss,
der gleichzeitig als Wärmeableiter konzipiert ist. Wenn eine konventionelle
Kontaktierung bei kleinen Bauformen nicht mehr möglich ist, muss man zum
Thermokompressionsverfahren greifen, in dem man einen feinen Golddraht über
der Kontaktstelle platziert und mittels einer Spitze bei etwa 300░C in Schutzgas
andrückt. Neben solchen npn-Transistoren kann man auf ähnliche Weise auch
eine pnp-Bauform erzeugen. Auch hier werden die Transistoren wie beim älteren
Typ zu einer Mesa-Form geätzt.
Leider litten auch noch die Mesa-Transistorformen darunter, dass sie der
Umbebung nahezu ungeschützt ausgeliefert waren.
Als nächstes entwickelte man 1962 die Epitaxietechnik. Bei ihr wird
ein Wafer bei etwa 1200░C z.B. einem Dampf aus Siliziumtetrachlorid und
Wasserstoff ausgesetzt, letzterer reduziert das Tetrachlorid zu reinem Silizium,
welches bei der hohen Temperatur gut an die Kristallstruktur anwächst. Den
Dotierungsgrad der angewachsenen Schicht bestimmt man durch Zugabe eines
Störstoffes zum Dampf. Epitaxie ist aber nicht nur unter Zuhilfenahme von
Gas möglich, sondern gelingt auch, wenn man unter entsprechenden Bedingungen
ein Wafer flüssigem Halbleiterstoff aussetzt. Auch gibt es eine Methode,
bei der ein Strahl der anzulagernden Atome auf das Wafer gerichtet wird,
die mit niedrigerer Temperatur auskommt. Beim zuerst geschilderten Verfahren
diffundieren durch die hohe Temperatur aufgelagerte Atome in das Wafer,
so dass eine Herstellung von abrupten Sperrschichten angesichts der Diffusion
von Dotieratomen schlecht möglich ist. Die anderen beiden Verfahren sind
in dieser Hinsicht vorteilhafter, jedoch nicht so weit verbreitet. Mit Epitaxietechnik
kann man ein Problem der herkömmlichen Transistoren eliminieren, das darin
besteht, dass die notwendigerweise sehr schwach dotierten Kollektoren einen
hohen Bahnwiderstand gegen den durchfließenden Strom mit sich bringen. Verwendet
man stattdessen ein hochdotiertes Wafer mit niedrigdotierter Epitaxieschicht
als Übergang zur Basis, so hat der Kollektor in der Übergangszone zur Basis
die geforderte schwache Dotierung, ist aber ansonsten sehr leitfähig und
stellt für den Strom nicht mehr so ein großes Hemmnis dar. Auch die Basis
kann man epitaktisch herstellen.
Man stellte nach Erfindung dieses Verfahrens auch Mesatransistoren
mit epitaktischer Grundplatte, d.h. mit einer in eine Epitaxieschicht eindiffundierten
p-Schicht her. Dabei muss die Epitaxieschicht natürlich noch unter die p-Schicht
hineinragen, d.h. die p-Schicht darf nicht zu weit eindiffundiert werden.
4.3) Ionenimplantation; das Planarverfahren
Ein heute oft auch statt der Diffusion verwandtes Verfahren, das für das
Planarverfahren auch herangezogen wird, heißt Implantation und basiert darauf,
dass man das zu dotierende Material mit beschleunigten und durch E/B-Felder
fokussierten Ionen des Dotierstoffes beschießt. Da bei der Implantation
die Kristallstruktur leidet, muss der Kristall danach noch einige Zeit hocherhitzt
werden, damit sich die richtige Anordnung der Atome im Gitter wiederherstellt
(ausheilen).
Wie sieht nun das Planarverfahren, nach dem man heute üblicherweise FETs
und Transistoren herstellt, genauer aus? Zunächst einmal sei gesagt, das
es einerseits auf Diffusions-/Implantationsverfahren gründet, andererseits
aber auch auf der Erkenntnis, dass sich Silizium, wenn man es in einem Gemisch
aus Wasserdampf und Sauerstoff auf ca. 1200░ erhitzt, mit einer isolierenden
Siliziumdioxid-Schicht überzieht. Weiterhin macht diese Technik exzessiven
Gebrauch von Maskierungs- und Ausätzverfahren.
Die einzelnen Arbeitsschritte zur Erstellung eines Bipolartransistors sind
folgende:
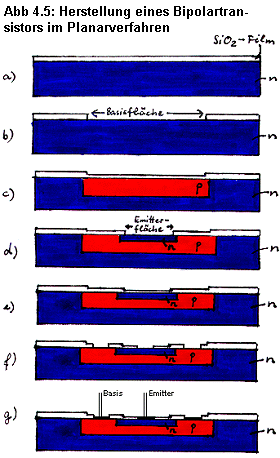 Zunächst wird eine dünn
geätzte, in diesem Beispiel n-dotierte Si-Scheibe oft auch mit epitaktischer
Schicht an der Oberseite) mit Siliziumdioxid (Schritt a) und einem lichtempfindlichen
Photolack überzogen. Dann belichtet man die Scheibe durch eine Maske mit
kleinen Fenstern (ca. 1000 Fenster auf einer Kristallscheibe mit 2,5cm Durchmesser!).
Der Photolack wird nun chemisch entwickelt, d.h. er löst sich an den belichteten
Stellen auf, und danach lässt man ihn, wo er verblieben ist, aushärten.
Nun wird das Plättchen einer Ätzlösung ausgesetzt, die den Photolack in
der Ätzzeit nicht aufzulösen vermag, wohl aber die freiliegenden Siliziumdioxidbereiche.
An den vorher belichteten Stellen liegt also das Silizium frei (Schritt
b), und man kann es unter hohen Temperaturen einem Bordampf aussetzen, der
p-dotierte Zonen unter den Fenstern schafft. Nun oxidiert und lackiert man noch mal (Schritt c) und belichtet
diesmal durch kleinere Fenster, deren Mittelpunkte an denselben Stellen
wie vorher liegen. Der Lack wird entwickelt und es wird geätzt (Schritt
d), diesmal liegen kleinere Teilflächen der p-Flächen frei. Hier lässt
man n-dotierende Atome von Phosphor nach demselben Verfahren wie oben eindiffundieren,
wodurch schließlich die Schichtfolge n-p-n entstanden ist. Noch einmal
folgt ein Oxidations- (Schritt e) / Belichtungs- / Ätzvorgang, bei dem sich am Schluss genau Fenster an den Anschlussstellen
für die p-dotierten Basen (siehe Bild) und die ganz oben liegenden n-Emitter
befinden (Schritt f; der Kollektor kann an der Unterseite des Kristalls
angeschlossen werden). In einer Vakuumkammer dampft man auf die gesamte
Plättchenfläche Aluminium zur Kontaktierung auf, und ätzt dann nach einer
Fotomaskierung die nicht benötigten Aluminiumzonen wieder frei. Man zerlegt
das Plättchen in Einzeltransistoren und kontaktiert mittels Thermokompressionsverfahren
(Schritt g).
Zunächst wird eine dünn
geätzte, in diesem Beispiel n-dotierte Si-Scheibe oft auch mit epitaktischer
Schicht an der Oberseite) mit Siliziumdioxid (Schritt a) und einem lichtempfindlichen
Photolack überzogen. Dann belichtet man die Scheibe durch eine Maske mit
kleinen Fenstern (ca. 1000 Fenster auf einer Kristallscheibe mit 2,5cm Durchmesser!).
Der Photolack wird nun chemisch entwickelt, d.h. er löst sich an den belichteten
Stellen auf, und danach lässt man ihn, wo er verblieben ist, aushärten.
Nun wird das Plättchen einer Ätzlösung ausgesetzt, die den Photolack in
der Ätzzeit nicht aufzulösen vermag, wohl aber die freiliegenden Siliziumdioxidbereiche.
An den vorher belichteten Stellen liegt also das Silizium frei (Schritt
b), und man kann es unter hohen Temperaturen einem Bordampf aussetzen, der
p-dotierte Zonen unter den Fenstern schafft. Nun oxidiert und lackiert man noch mal (Schritt c) und belichtet
diesmal durch kleinere Fenster, deren Mittelpunkte an denselben Stellen
wie vorher liegen. Der Lack wird entwickelt und es wird geätzt (Schritt
d), diesmal liegen kleinere Teilflächen der p-Flächen frei. Hier lässt
man n-dotierende Atome von Phosphor nach demselben Verfahren wie oben eindiffundieren,
wodurch schließlich die Schichtfolge n-p-n entstanden ist. Noch einmal
folgt ein Oxidations- (Schritt e) / Belichtungs- / Ätzvorgang, bei dem sich am Schluss genau Fenster an den Anschlussstellen
für die p-dotierten Basen (siehe Bild) und die ganz oben liegenden n-Emitter
befinden (Schritt f; der Kollektor kann an der Unterseite des Kristalls
angeschlossen werden). In einer Vakuumkammer dampft man auf die gesamte
Plättchenfläche Aluminium zur Kontaktierung auf, und ätzt dann nach einer
Fotomaskierung die nicht benötigten Aluminiumzonen wieder frei. Man zerlegt
das Plättchen in Einzeltransistoren und kontaktiert mittels Thermokompressionsverfahren
(Schritt g).
Das Verfahren erlaubt in der Praxis eine gute Bestimmung von Diffusionslängen
und Eigenschaften des Endproduktes, es ist in der Massenfertigung sehr erfolgreich.
Die Oxidschicht schützt und isoliert die Strukturen derartig gut, dass Planartransistoren
beinahe noch mit zerbrochenem Gehäuse in kochendem Wasser funktionieren.
Auch hier lassen sich auf ähnliche Art pnp-Transistoren herstellen, oft als
Pendants (Komplementärtransistoren) zu npn-Transistoren mit genau entsprechenden
elektrischen Daten, aber umgekehrter Dotierung, da manche Anwendungen den
Einsatz von Komplementärpaaren erfordern.
Auch Feldeffekttransistoren werden in einer Reihe von Planar-Verfahren
hergestellt, wobei natürlich die Folge der epitaktisch aufgewachsenen oder
im Planarverfahren hergestellten bzw. implantierten Schichten anders ist.
Beim MOSFET muss schlussendlich über dem Gate ein reiner Siliziumdioxidfilm
bestehen bleiben, auf den dann direkt aufkontaktiert wird. Will man einen
MOSFET-Verarmungstyp erzeugen, so wird zwischen Drain und Source der oberflächliche
Kanal z.B. durch Implantation geschaffen.
Die Liste der durch findige Forscher eingeführten technischen Neuerungen
und Verfahren für die MOSFET-Herstellung nimmt kein Ende, so implantiert
man beispielsweise heute oft die Source- und Drain-Bereiche erst, nachdem
man das Gate erzeugt hat. Die Ionen, mit denen der Kristall geschossen wird,
durchdringen das Gate überhaupt nicht und so hat man unter der Gateelektrode
auch keine hineinwuchernden Source- oder Drain-Bereiche, die zu unnötigen
Kapazitäten zwischen Gate und Source/Drain führen würden. Auch finden sich
diese MOSFET-Bauelemente massenhaft in integrierten Schaltkreisen, und es
werden immer neue Produktionsverfahren für noch höhere Packungsdichte, aber
auf der anderen Seite auch für möglichst verlustarme diskrete, d.h. einzelne
und nicht in IC verbaute Leistungs-MOSFETs erfunden.
5) Kennlinien von Bipolartransistoren und Charakteristka dieses Transistortyps
Der praktische Teil meiner Facharbeit bestand aus langwierigen und teils
frustrierenden Messungen (zur Herstellung von Transistorkennlinien) mit
neuen experimentalphysikalischen Erfahrungen, die durch einen Messcomputer
und eine nicht immer einwandfreie Schaltungsanordnung erzeugt wurden. Daher
werde ich nachfolgend auch schildern, wie man die Versuche erfolgreich durchführt
und auswertet. Es kamen schließlich nach Überwindung aller Probleme recht
ansehnliche Kennlinienfelder heraus, die hauptsächlich drei Relationen zwischen
verschiedenen Eingangs- und Ausgangsgrößen von npn-Transistoren verschiedener
Leistungsstufen erfassen. Man hätte auch pnp-Transistoren mit umgepolten
Versuchsanordungen messen können, aber dies bringt lediglich entgegengesetzt
gepolte und nicht wirklich andere Ergebnisse. Die Transistoren waren im
Einzelnen:
Der BC547B,
ein Transistor der Kleinleistungsklasse (bis zu 200mA Schaltstrom möglich)
ohne Kühlungsmöglichkeit
Der BD135,
der immerhin 2A schaltet, also ein Mittelleistungstransistor
Der BD249,
ein Leistungstransistor (bis 40A Schaltstrom einsetzbar) der für Hochstrommessungen
ebenso wie der BD135 standesgemäß auf einen Kühlkörper montiert wurde
Diejenigen Eigenschaften von Bipolartransistoren, die man an den Kennlinien
besonders gut erkennen kann, werden in diesem Teil der Arbeit im Rahmen
der Kennlinieninterpretation besprochen.
5.1) Messanordnung; Auswertungsverfahren; Vergleichsverfahren
Zuerst möchte ich einmal die Grundschaltung des Transistors vorstellen:

|
Diese Grundschaltung beinhaltet zwei Stromquellen, einmal die Basisstromquelle,
die den Injektionsgrad in den Basisraum bestimmt und andererseits die Kollektorstromquelle,
die einen von diesem Injektionsgrad abhängigen Strom Ice, der
(Stromverstärkung!) deutlich höher ist als Ibe, möglich macht.
Während die Kollektorstromquelle genau genommen Spannungsquelle genannt
werden müsste, da sie stets im Konstantspannungsmodus arbeitet, ist bei der
Basis bei den Uce-Ice-Versuchen eine Konstantstromansteuerung
erwünscht. Dazu wird die Basisstromquelle auf ca. 20 V aufgedreht und ein
entsprechendes, selbstgebautes Konstantstrommodul in IC-Technik genau auf
die selbe Weise wie ein Strommessgerät in den Basisstromkreis eingeschaltet.
Das Konstantstrommodul hat die Aufgabe, die Spannung der Basisstromquelle
immer gerade so zu reduzieren, dass durch die Basis genau der Strom fließt,
den man haben möchte. Dieser Strom ist am Modul mittels Potentiometer schnell
einstellbar. Das Basisnetzteil muss so hoch aufgedreht werden, damit, sollte
sich die Basis gegen den hereinkommenden Strom etwas wehren (das macht
sie auch manchmal, indem der Spannungfall an ihr schwankt, wenn man z.B.
U ce verändert), das IC notfalls voll durchschalten kann und die
Elektronen dann durch eine mörderische Spannung von 17V aus der Basis gezogen
werden. So viel ist nie nötig, aber es kann nie schaden, wenn die Konstantstromquelle
möglichst ideal, d.h. unabhängig vom Lastwiderstand stabilisiert. Wenn man
es ohne Modul versucht, die Konstantstromansteuerung mit einer Konstantspannungsquelle
zu bewerkstelligen, so merkt man bald, dass dies keinen Zweck hat, da sich
der Basisstrom bei gleichbleibender anliegender Spannung durch interne Rückwirkungen
ändert und die Messwerte verfälscht werden (schließlich wollte man sie ja
unter Annahme eines konstanten Basisstroms aufnehmen). Die Leitungsdrähte
der Messschaltung sind möglichst kurz zu halten, damit Spannungsabfälle
und Störeinstreuungen durch Wechselfelder unterbleiben.
Nun zum Messcomputer und den richtigen Messmethoden:
Das Cassy-Messinterface für PCs hat mehrere Messeingänge, an denen allesamt
nur Spannungen über einen ausreichend hohen Innenwiderstand, der die Messanordnungen
normalerweise nicht verfälscht, gemessen werden können. Strommessungen finden
als Spannungsmessungen über einen externen Messwiderstand von 1 Ohm (in der Windows-Version
des Messprogrammes) statt, wobei der Messbereich bei 0.3, 3, 1 oder 3A endet,
folglich also 0.3, 1 oder 3V der maximale Spannungsfall, den das Cassy in
diesem Modus misst, ist. Misst man einen geringeren Strom, so wählt man
einen z.B. zehnmal oder hundertmal so großen Widerstand, so dass möglichst
volle 0.3, 1 oder 3V am Cassy-Eingang anliegen, damit die im Kleinstspannungsbereich
prozentual sehr hohen Messfehler nicht auftreten. Mittels der Programmfunktion
Formel kann man die Messwerte dann für eine spätere Auswertung automatisch
durch den Widerstandswert dividieren lassen, so dass die Stromwerte wieder
korrekt sind, obwohl das Cassy Werte misst, die mit dem Widerstandswert multipliziert
sind (über einen 100-Ohm-Widerstand fällt 100
mal so viel Spannung ab). Neben den Messfehlern gibt es ein zweites Problem
mit dem Cassy: Die Messeingänge haben einen gemeinsamen, geerdeten Masseanschluss.
Daher sind Messungen verschiedener Größen in einer Schaltung manchmal nur
mit Tricks, schlimmstenfalls nur unter Einsatz eines galvanisch trennenden,
die Messwerte selbst wieder verfälschenden Optokopplers möglich. Letzteres
habe ich jedoch erfolgreich vermieden. Die gemessenen Kennlinien stellen
immer den Zusammenhang zwischen zwei Messgrößen dar. Wenn diese Kurven Scharen
in Abhängigkeit eines Parameters sind, so wurde der Parameter niemals mit
dem Cassy gemessen, da dann drei Messgrößen von einem gemeinsamen Massepunkt
in der Schaltung aus gemessen werden müssten. In so einem Fall ist es folglich
besser, ein genaues Digitalamperemeter zu verwenden. Weiterhin ist es wichtig,
mittels eines Digitalamperemeters, dass in die Massezuleitung des Cassy
geschaltet wird, einmal zu verifizieren, dass aus der Schaltung kein Strom
in die Erdung des Cassy abfließt, was Messungen unzuverlässig oder unmöglich
machen würde. Ein solches Problem tritt jedoch nur mit geerdeten Netzteilen
auf, und es gibt durchaus ungeerdete Netzteile, was man bei dieser Überprüfung
feststellen wird.
Die einzelnen Schaltungsanordnungen zu den Messungen sind nochmals über
den Kennlinien zu finden. Bei der Messung selbst wurde die auf der Rechtswertachse
angetragene Größe mittels Einstellknopf am entsprechenden Netzteil verändert.
Die einzelnen Kennliniendiagramme wurden nicht direkt mit dem Cassy-Programm
erstellt, da Excel bessere Graphikfähigkeiten besitzt. Die Messdaten wurden
im Cassy-Programm als Ascii-Tabelle von zeitlich aufeinanderfolgenden Messwertpaaren
exportiert. Die Scharkurven sind in diesen Ascii-Tabellen gut zu erkennen,
weil die Messwerte zuerst ansteigen, und dann ab einem Peak-Wert wieder
absinken, da für die Darstellung mehrerer Kennlinien im Cassy-Programm eine
Rückkehr der Werte zum Nullpunkt vor Aufnahme der nächsten Scharkurve nötig
war. Man erhält nun sinnvolle Kurven, indem man alle Nullwerte und alle
den Messbereich übersteigenden Werte (dies sieht man daran, dass mindestens
eine der beiden Größen über längere Zeit den Wert einer Messbereichsgrenze
einnimmt) aus den Datenreihen eliminiert, und dann die steigenden Kennlinien
herauskopiert, da die fallenden nur Duplikate von ihnen darstellen. Da die
Werte zeitlich aufeinanderfolgen und manchmal die x-Werte der Paare schwanken,
müsste Excel die Kurven immer vor- und zurückzeichnen. Das erspart man dem
Programm, indem man die Werte noch sortiert. Die so gewonnenen Kennlinien
beinhalten zwar auch noch Messwertschwankungen und leichte Mängel, wie zum
Beispiel teilweise Einflüsse durch Transistorerwärmung, aber man kann die
wichtigsten Effekte recht gut an ihnen erkennen, zumal ich mich sehr um Fehlerminimierung
bemüht habe.
Im Rahmen der Kennliniendiskussion fallen bei einem
Vergleich der Kennlinien des BC547B und denen der Mittel- bzw. Hochleistungstransistoren
und auch bei einem Vergleich der BD135-Linien mit denen des BD249 gewisse,
immer gleiche, bauartbedingte Unterschiede zwischen einem leistungsfähigeren
und nicht so leistungsfähigen Typ auf. Da diese verständlicherweise zwischen
BC547B und BD249 am größten sind, werden in Vergleichen hauptsächlich deren
Kennlinienfelder einander gegenübergestellt.
5.2) Ube-Ibe-Kennlinien
Die sicherlich am einfachsten zu betrachtende Kennlinienart,
nämlich die Ube-Ibe-Eingangskennlinien kennt man schon
von den Dioden, denn nichts anderes ist ein solcher Transistoreingang. Da
die Kennlinien unter den Transistoren fast nicht differieren, genügt ein
Feld des BD135 zur Betrachtung. Zur Messung benötigt man keine Konstantstromquelle.
Messwerte:
Auswertung:
Bei Überwindung der Antidiffusionsspannung fließt ein Strom über den E-B-Übergang.
Dieser Strom ist bei angelegter Kollektorspannung und gleichbleibender Basisspannung
niedriger. Dadurch kann man aus den Kurven eine Schar mit verschiedenen
Kollektorspannungen als Parameter bilden.
5.3) Ibe-Ice-Kennlinien; Ice-B-Kennlinien
Etwas interessanter wird das ganze, wenn wir wirklich
die Hauptfunktion des Transistors, nämlich die eines Leistungsverstärkers
betrachten. Im folgenden möchte daher ich den Zusammenhang zwischen Basisstrom
und Kollektorstrom ansehen. Die Kurvenscharen stellen ihn mit verschiedener
anliegender Kollektorspannung dar, der Zusammenhang zwischen Kollektorspannung
und strom wird weiter unten noch genauer erläutert. Der Basisstrom wird
auch hier nicht mittels einer Konstantstromquelle eingestellt, sondern einfach
durch Erhöhen der Basisspannung gesteigert. Wenn er kurzzeitig schwankt,
so wird dieser Effekt durch den oben bei den Auswertungsmethoden angesprochenen
Sortiervorgang unschädlich gemacht.
Messwerte:
Man sieht, dass der Ibe-Ice-Zusammenhang in einigen
Bereichen (man betrachte die blaue Linie) nicht linear ist. Zur Unterstützung
der Begründung hierfür berechnet man den Quotienten B aus Kollektorstrom
und Basisstrom, den man Gleichstromverstärkungsfaktor nennt.
Auswertung:
Der Verlauf von B über den Kollektorstrombereich ist verantwortlich für
die teilweise Nichtlinearität der Ibe-Ice-Funktion.
In ganz niederen Bereichen ist der Stromverstärkungsfaktor relativ niedrig,
was genauere Transistormodelle auf einige Störeffekte zurückführen. Er steigt
steil an, bis er, auch noch bei relativ niedrigem Kollektorstrom, sein Maximum
erreicht. Nun betrachten wir dieselbe Kurve, nur für den Hochleistungstransistor
BD 249.
Auswertung:
Wenn auch die Höhe der Maxima durch Messwertschwankungen etwas
Ā verfälscht wurde, erkennt man, dass der Kleinleistungstransistor
BC 547 bei der Höhe des Maximums auf jeden Fall einen Vorteil gegenüber
dem Hochleistungstransistor BD 249 hat, er ist also für die Verstärkung
kleiner Leistungen besonders geeignet. Wenn jedoch der Basisstrom gesteigert
wird, werden vom Emitter mehr Minoritätsträger in das Basisgebiet injiziert.
Die negativen Ladungen ziehen aber wiederum positive Ladungen aus dem Basisanschluss,
und dieser Basisstromanteil fängt Elektronen, die eigentlich zum Kollektor
sollen, durch Rekombination weg. Daher muss der Basisstrom für eine weitere
Erhöhung des Kollektorstroms überproportional gesteigert werden, da ja ein
höherer Anteil von ihm für den Transistoreffekt unwirksam ist. Das heißt
aber nichts anderes, als dass der Stromverstärkungsfaktor langsam aber sicher
absinkt, wenn man den Transistor ausreizt. Bei Leistungstransistoren ist
B bauartbedingt über weitere Bereiche fast gleichbleibend, wie man an den
Kennlinien sieht.
5.4) Uce-Ice-Kennlinien
Die Uce-Ice-Kennlinien sind
Scharkurven für verschiedene Basiskonstantstrom-Parameterwerte, wobei der
Basisstrom von einer Kurve zur nächsthöheren in der Regel (außer es ist anders
angegeben) konstant gesteigert wurde. Ich habe für den BD249 drei Kennlinienfelder
für kleine, mittlere und große Basisströme erstellt.
Messwerte:
Auswertung:
Zunächst kann man die Kennlinien von links nach rechts
gesehen in zwei Bereiche unterteilen. Im linken Bereich ist die Spannung
am Kollektor zu klein, um alle von der Basis angelieferten Elektronen mitzureißen,
d.h., grob gesagt, kleiner als die Basisspannung. Daher könnte durch die
B-C-Diode fast schon ein Durchlassstrom entgegen der normalen Richtung in
Richtung Basis fließen, würde diese nicht noch ihre Antidiffusionsspannung
gegen einen solchen Strom setzen. Das Ende dieses Sättigungsbereiches ist
da, wo die Kennlinien in den waagerechten Bereich abknicken. Da hier immer
alle durch den E-B-Übergang lieferbaren Elektronen vom Kollektor abgesaugt
werden, bleibt der Strom bei den Linien unter niedriger Belastung fast konstant,
wenn sich die Kollektorspannung ändert (aktiver Betriebsbereich). An den
Linien unter höherer Auslastung bemerkt man im aktiven Bereich aber immer
noch eine gewisse Steigung. Dies rührt vom sogenannten Early-Effekt her,
der, mathematisch gefasst, besagt, dass, weil sich die Verarmungszone bei
p-n-Übergangen mit höherer Sperrspannung immer weiter ausdehnt, die Weite
des nicht verarmten Basisraumes und damit des für z.B. Rekombinationseffekte
relevanten Basisraums mit steigender Uce sinkt. Dass nur der nicht
verarmte Basisraum für Rekombinationseffekte relevant ist, rührt daher, dass,
wie man beweisen konnte, am basisseitigen Ende dieser Verarmungszone genau
die Wirkung des Kollektor-E-Feldes und damit der Ladungsträgerabtransport
zum Kollektor beginnt. Rekombinationen im Basisraum finden somit immer weniger
statt, wodurch der Stromverstärkungsfaktor mit steigender Uce
steigt. Offensichtlich wirkt sich dieser Effekt bei hohen Basis/Kollektorströmen
besonders stark aus. Wenn die Verarmungsgrenze die B-E-Sperrschicht erreicht,
so werden Elektronen unabhängig vom Basisstrom sofort vom Kollektor aus
dem Emitter gezogen, was einen Durchbruchseffekt (in diesem Fall Durchgriff
oder auch punch-through genannt) zur Folge hat. Diesen würde man bei entsprechend
hoher Spannung am Abknicken der Kennlinien nach oben erkennen. Nach diesem
Durchbruch erfolgt ebenso wie nach einem Lawinendurchbruch (auch Avalanchedurchbruch;
=Stoßionisation bei Überspannung) oft eine Überhitzung einzelner Kristallzonen,
die wiederum in diesen Zonen zu noch höheren Strömen durch erhöhte Eigenleitung
führt, und damit schließlich eine Zerstörung des Bauteils (zweiter Durchbruch).
Den Early-Effekt und den punch-through versucht man zu vermindern, indem
man den Kollektor am schwächsten dotiert, wodurch sich die B-C-Sperrschicht
bei Spannungserhöhungen hauptsächlich in die Kollektorzone ausbreitet (dies
kann man wiederum mathematisch-quantitativ beweisen).
Nun noch etwas zur vertikalen Aufteilung des Kennlinienfeldes.
Man sieht am in vielen Bereichen gleichmäßigen Abstand der Kennlinien, dass
sich der Transistor durch eine Basisstromänderung oft linear ansteuern lässt.
Wenn der Kollektorstrom Grenzauslastungswerte erreicht, rücken sie allerdings
näher zusammen, was auf eine niedrigere Stromverstärkung hindeutet. Die
Sättigung tritt bei höherem Kollektorstrom ebenfalls erst später ein. Diese
beiden Effekte sind beim BD249 zwar erkennbar, aber man benötigt schon ein
gutes Auge. Doch den BC547B suchen die Effekte, da er für kleinere Ströme
gebaut wurde, schon im Diagramm mit den mittleren Basisströmen ungemein heim:
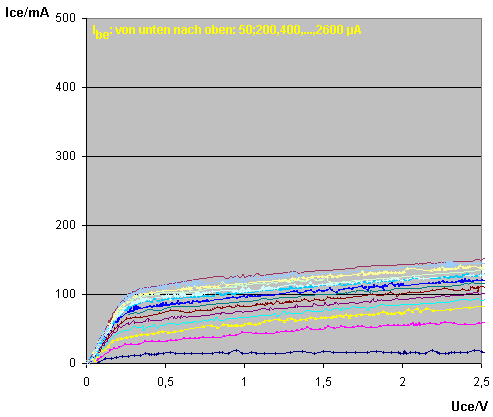
|
Man beachte, dass
delta-Ibe von der
unteren blauen Linie zur nächsthöheren kleiner ist als
delta-Ibe von der
rosanen zur nächsten, gelben Linie. Dennoch steigt Ice nicht
mehr so stark wie vorher. Auch ist die blaue Linie viel waagerechter, an
der rosanen bemerkt man schon deutlich die durch den Early-Effekt verursachte
Steigung. Bei den höchsten Basisströmen ist der Abstand zwischen den einzelnen
Scharkurven fast schon in der Messtoleranz, obwohl Ibe in diesem
Bereich immer äquidistant gesteigert wurde.
Spannungsansteuerung:
Zum Spaß habe ich noch einmal denselben Zusammenhang
an einem BD135 untersucht, wobei sich die Scharkurven aber in diesem Versuch
durch eine konstante, sich von Kennlinie zu Kennlinie im Gleichmaß steigernde
Eingangsspannung und nicht durch konstante Basisströme unterscheiden. Wenn
die Stromansteuerungscharakteristik (Ibe-Ice-Felder)
in großen Bereichen zumindest annähernd linear ist, und der Zusammenhang
zwischen Basisspannung und Basisstrom (Diodenkennlinien) überhaupt nicht,
so kann eine Spannungsansteuerung in diesen Bereichen niemals den Kollektorstrom
linear steigern.
Was ich gerade theoretisch begründet habe, kennt man
im Kennlinienfeld sehr gut daran wieder, dass alle Linien unterschiedlich
weit voneinander entfernt sind. Daher ist der Versuch einer linearen Spannungsansteuerung
in weiten Betriebsbereichen erfolglos.
5.5) Vierquadrantendarstellung der Kennlinienfelder
Schaltungsentwickler bedienen sich oft einer besonderen Darstellung der
Kennlinien, der Vierquadrantendarstellung, wie man sie an diesem Beispiel
für den BD135 sieht.
Die Vierquadrantendarstellung setzt verschiedene Ein- und Ausgangsgrößen miteinander in Bezug. So kann man
zum Beispiel, wenn man die Ansteuerspannung Ube weiß, sofort
I be und damit auch, wenn man eine Linie senkrecht nach oben
zieht, I ce ablesen. Eine solche Kombination von Spannungs-/Stromwerten
im Betriebszustand beschreibt den sogenannten Arbeitspunkt des Transistors,
der bei der Schaltungskonzeption eine wichtige Rolle spielt, nicht zuletzt,
weil der Transistor nicht zu hoch belastet werden darf. Zudem kann man das
rechte, obere Kennlinienfeld noch mit geschickten Tricks dazu benutzen, den
Transistor umgebende Bauteile in die graphischen Überlegungen miteinzubeziehen.
6) Quellenverzeichnis
Jean Pütz: Einführung in die Elektronik, erschienen am 1971 im Fischer-Taschenbuch-Verlag
Winfried Knobloch: Transistorschaltungen selbst entwickeln, erschienen
1985 im Franzis-Verlag, München
Joachim Goerth: Bauelemente und Grundschaltungen, erschienen 1999 im Teubner-Verlag,
Stuttgart/Leipzig
Reinhold Paul: Elektronische Halbleiterbauelemente, erschienen 1989 im
Teubner-Verlag, Stuttgart
Andreas Schlachetzki: Halbleiter-Elektronik, erschienen 1990 im Teubner-Verlag,
Stuttgart
Stanley W. Amos: Transistorschaltungen Entwurf und Arbeitsweise, erschienen
1991 im VCH-Verlag, Weinheim
Mike Cooke: Halbleiterbauelemente, erschienen 1993 im Hanser Verlag, München
Lehrprogramme Elektrotechnik, Reihe III Elektronik, Band 1, herausgegeben
1979 vom Bundesinstitut für Berufsbildung, Berlin
Erwin Böhmer: Elemente der angewandten Elektronik Kompendium für Ausbildung
und Beruf, erschienen 1998 im Vieweg Verlag, Braunschweig/Wiesbaden
Rumpf, Pulvers: Elektronische Halbleiterbauelemente, erschienen 1987 im
Dr. Alfred Hüthig Verlag, Heidelberg / 1987 im VEB Verlag Technik, Berlin
Albrecht Möschwitzer: Halbleiterelektronik Ein Wissensspeicher, erschienen
1993 im VCH-Verlag, Weinheim
Bauer/Wagener: Bauelemente und Grundschaltungen der Elektronik, Band 1,
erschienen 1989 im Hanser-Verlag, München
Schoppnies, Erhard: Halbleiterelektronik, erschienen 1988 im Bibliographischen
Institut, Leipzig
Nühmann: Transistor-Praxis, erschienen 1986 im Franzis-Verlag, München
Eckert/Schubert: Kristalle, Elektronen, Transistoren, erschienen 1986 im
rororo-Verlag, Hamburg
Physics Today, Ausgabe April 1992: Mehrere Artikel über John Bardeen, den
Erfinder des ersten Transistors
Michael Buchholz: Einführung in die Halbleitertechnik, Referat im LK Physik
1999/2001 (HHG)
Andrķ Langhorst: Transistoren, Referat im LK Physik, www.referate.ch, siehe
auch Ausdruck, aufgerufen am 15.1.2000
Gespräch mit Herrn Jordan über den Sperrzustand, Inhalt siehe angefügte
Blätter
The Early History of the Transistor, aufgerufen am 6.9.2000, http://ourworld.compuserve.com/homepages/Andrew_Wylic/history.htm
Elektroniknet Fachthemen Bauelemente: Alles Gute zum Geburtstag!
Teil 2/2, aufgerufen am 6.9.2000, http://www.elektroniknet.de/fachthemen/bauelemente/artikel/ek9726b_3.htm
Beschreibung des Bipolartransistors, aufgerufen am 3.9.2000, http://www-es.fernuni-hagen.de/~jfh/grundlagen/node4.html
Transistorized!, aufgerufen am 3.9.2000, http://www.pbs.org/transistor/album1/index.html
Point Contact Transistor, aufgerufen am 4.1.2001, http://www.pbs.org/transistor/science/events/pointctrans.html
Interview with Holonyak about John Bardeen, the inventor of the transistor,
aufgerufen am 4.1.2001, http://www.ieee.org/organisations/history_center/oral_histories/transcripts/holonyak.html
Transistors The Unijunction Transistor, aufgerufen am 17.09.2000, http://tpub.com/neets/book7/26h.htm
MISFET (transistors), aufgerufen am 25.1.2001, http://www.cas.org/vocabulary/06790.html
MESFET (transistors), aufgerufen am 25.1.2001, http://www.cas.org/vocabulary/06824.html
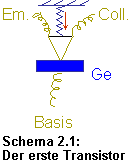 Der Teamleiter, William Bradford
Shockley, versuchte schon im Frühjahr 45, einen Prototyp eines Feldeffekt-basierten
Verstärkerbauteils zu bauen, dieser Versuch mißlang jedoch. Schließlich konnten zwei
Physiker, der brilliante Theoretiker John Bardeen, und der Experimentalphysiker Walter Houser
Brattain, die Entwicklung mit viel trial and error vorantreiben und 1947 den ersten
point-contact-transistor (zu deutsch: Spitzentransistor) entwickeln. Dieser bestand aus
Goldstreifen auf einem Plastikdreieck, das mit einer entgrateten Spitze auf einer
Germaniumplatte des n-Typs aufstieß (Abb.2.1). Durch Anlegen einer positiven Spannung gegenüber der Basis an den Emitter wurden, was dem heutigen Prinzip des Transistors weitgehend ähnlich ist, aus dem positiven Goldemitter Löcher in die Basis injiziert, wodurch man
den Widerstand zwischen dem Kollektor und dem Germaniumkristall bei negativer Vorspannung
des Kollektors gegenüber der Basis beeinflussen konnte.
Shockley konnte sich dann etwas später wieder an die Spitze der Entwicklung setzen,
als er den Bipolartransistor in Sandwichbauweise, wie er in etwa heute miniaturisiert
und in einem Plastikgehäuse untergebracht gebräuchlich ist, erdachte. Es dauerte dann
noch ca. zwei Jahre, bis er zum ersten mal gebaut werden konnte.
Der Teamleiter, William Bradford
Shockley, versuchte schon im Frühjahr 45, einen Prototyp eines Feldeffekt-basierten
Verstärkerbauteils zu bauen, dieser Versuch mißlang jedoch. Schließlich konnten zwei
Physiker, der brilliante Theoretiker John Bardeen, und der Experimentalphysiker Walter Houser
Brattain, die Entwicklung mit viel trial and error vorantreiben und 1947 den ersten
point-contact-transistor (zu deutsch: Spitzentransistor) entwickeln. Dieser bestand aus
Goldstreifen auf einem Plastikdreieck, das mit einer entgrateten Spitze auf einer
Germaniumplatte des n-Typs aufstieß (Abb.2.1). Durch Anlegen einer positiven Spannung gegenüber der Basis an den Emitter wurden, was dem heutigen Prinzip des Transistors weitgehend ähnlich ist, aus dem positiven Goldemitter Löcher in die Basis injiziert, wodurch man
den Widerstand zwischen dem Kollektor und dem Germaniumkristall bei negativer Vorspannung
des Kollektors gegenüber der Basis beeinflussen konnte.
Shockley konnte sich dann etwas später wieder an die Spitze der Entwicklung setzen,
als er den Bipolartransistor in Sandwichbauweise, wie er in etwa heute miniaturisiert
und in einem Plastikgehäuse untergebracht gebräuchlich ist, erdachte. Es dauerte dann
noch ca. zwei Jahre, bis er zum ersten mal gebaut werden konnte. 1948 wurde die Erfindung des Spitzentransistors (über die Entstehung des Namens Transistor gibt es unterschiedliche Ansichten) von den Bell Labs publik gemacht, 1951 die Erfindung des Sandwich-Bipolartransistors. Im Jahre 1956 erhielten die drei Väter des Transistors für ihre Erfindungen den Nobelpreis für Physik.
1948 wurde die Erfindung des Spitzentransistors (über die Entstehung des Namens Transistor gibt es unterschiedliche Ansichten) von den Bell Labs publik gemacht, 1951 die Erfindung des Sandwich-Bipolartransistors. Im Jahre 1956 erhielten die drei Väter des Transistors für ihre Erfindungen den Nobelpreis für Physik. Im Jahre 1958 brachte Jack Kilby von TI das erste mal eine Schaltung aus mehreren
Transistoren auf einem Halbleiterkristall unter, und 1959 erfand Robert Noyce ein
ähnliches Bauteil unabhängig von Kilby bei Fairchild, wo man 1961 auch als erste Firma
die industrielle Fertigung von integrierten Flipflop-Schaltungen begann. Heute sind
solcherlei Bauelemente, ICs (integrated circuit, integrierte Schaltung, Abb. 2.3) genannt,
in fast jedem elektronischen Gerät anzutreffen. Mit der Zeit konnten in ihnen sehr komplexe
Schaltungen untergebracht werden, da die mögliche Transistordichte und Miniaturisierung durch
bessere Fertigungstechniken immer weiter erhöht wurde. Das Ergebnis dieser Entwicklungen sind
neben diversen Elektrogeräten mit minimierter Anzahl an diskreten (einzelnen) Transistoren
auch die heutigen Mikroprozessoren, die unter anderem die Basis der PCs darstellen. Ohne
diese programmierbaren hochintegrierten Transistorschaltungen, wäre der Computer für
Jedermann und auch die damit verbundene Gesellschaftsentwicklung undenkbar. Die Anzahl
der Transistoren in Prozessoren steigt ständig und verdoppelt sich in konstanten
Zeitabständen ungefähr, so dass der Pentium II-Prozessor schon 7,5 Millionen Transistoren
auf einem Chip enthielt, während der erste Intel-Prozessor 4004 im Jahre 1971 noch mit
2300 Transistoren rechnete. Auch wird die Schaltgeschwindigkeit (Taktung) der meist auf FETs
basierten Prozessoren immer höher und die Computer damit immer schneller.
Im Jahre 1958 brachte Jack Kilby von TI das erste mal eine Schaltung aus mehreren
Transistoren auf einem Halbleiterkristall unter, und 1959 erfand Robert Noyce ein
ähnliches Bauteil unabhängig von Kilby bei Fairchild, wo man 1961 auch als erste Firma
die industrielle Fertigung von integrierten Flipflop-Schaltungen begann. Heute sind
solcherlei Bauelemente, ICs (integrated circuit, integrierte Schaltung, Abb. 2.3) genannt,
in fast jedem elektronischen Gerät anzutreffen. Mit der Zeit konnten in ihnen sehr komplexe
Schaltungen untergebracht werden, da die mögliche Transistordichte und Miniaturisierung durch
bessere Fertigungstechniken immer weiter erhöht wurde. Das Ergebnis dieser Entwicklungen sind
neben diversen Elektrogeräten mit minimierter Anzahl an diskreten (einzelnen) Transistoren
auch die heutigen Mikroprozessoren, die unter anderem die Basis der PCs darstellen. Ohne
diese programmierbaren hochintegrierten Transistorschaltungen, wäre der Computer für
Jedermann und auch die damit verbundene Gesellschaftsentwicklung undenkbar. Die Anzahl
der Transistoren in Prozessoren steigt ständig und verdoppelt sich in konstanten
Zeitabständen ungefähr, so dass der Pentium II-Prozessor schon 7,5 Millionen Transistoren
auf einem Chip enthielt, während der erste Intel-Prozessor 4004 im Jahre 1971 noch mit
2300 Transistoren rechnete. Auch wird die Schaltgeschwindigkeit (Taktung) der meist auf FETs
basierten Prozessoren immer höher und die Computer damit immer schneller. Die gebräuchlichsten Halbleiter sind Silizium und Germanium, ihre Atome besitzen vier
Außenelektronen. In der natürlichen Kristallstruktur dieser Stoffe bindet sich jedes
der vier Außenelektronen eines Atoms mit einem Außenelektron des nächsten Nachbaratoms
(Abb 3.1). Alle Elektronen sind im Kristallgitter gebunden, und der Halbleiter leitet
nicht. Bei Erwärmung des Halbleiters (auch schon bei Zimmertemperatur) oder Zufuhr von
Photonen geeigneter Frequenz steigt die innere Energie des Materials an und Elektronen
können sich aus der Bindung losreißen und werden frei. Je heißer der Kristall wird oder
je mehr er Licht ausreichend hoher Freqenzen ausgesetzt wird, desto mehr wird verliert
damit er die Eigenschaften eines Isolators und nimmt die Eigenschaften eines Leiters an,
da freie Ladungsträgerpaare generiert werden, indem sich Elektronen losreißen und jetzt
am Atom eine negative kernladungsausgleichende Ladung fehlt.
Die gebräuchlichsten Halbleiter sind Silizium und Germanium, ihre Atome besitzen vier
Außenelektronen. In der natürlichen Kristallstruktur dieser Stoffe bindet sich jedes
der vier Außenelektronen eines Atoms mit einem Außenelektron des nächsten Nachbaratoms
(Abb 3.1). Alle Elektronen sind im Kristallgitter gebunden, und der Halbleiter leitet
nicht. Bei Erwärmung des Halbleiters (auch schon bei Zimmertemperatur) oder Zufuhr von
Photonen geeigneter Frequenz steigt die innere Energie des Materials an und Elektronen
können sich aus der Bindung losreißen und werden frei. Je heißer der Kristall wird oder
je mehr er Licht ausreichend hoher Freqenzen ausgesetzt wird, desto mehr wird verliert
damit er die Eigenschaften eines Isolators und nimmt die Eigenschaften eines Leiters an,
da freie Ladungsträgerpaare generiert werden, indem sich Elektronen losreißen und jetzt
am Atom eine negative kernladungsausgleichende Ladung fehlt.
 Daher wurde effektiv auch
noch eine positive Ladung, Loch genannt, generiert und man spricht vom Paar. Diese
sogenannte Eigenleitung ist aber für den Transistor nicht von Nutzen. Es gibt nämlich
noch eine zweite Möglichkeit, Halbleiter leitend zu machen: Die Einbringung von
Fremdatomen in den Kristall (Dotierung). Indem die Siliziumschmelze mit drei- oder
fünfwertigen Atomen gezielt verschmutzt wird, wobei ein übliches Verhältnis von
Grundstoff zu Fremdstoff im resultierenden Kristall 1:1000000 ist, wird das Gefüge
der gebundenen Elektronen im Kristallgitter gestört. Bei Einbringung von z.B. Antimon,
Phosphor oder Arsen (fünfwertig) kann ein Elektron des Fremdatoms nicht gebunden werden,
es ist somit beweglich und der Kristall leitfähig, man spricht von n-Leitendem
Halbleitermaterial mit Fähigkeit zur Störstellenleitung. Bei Verschmutzung mit
beispielsweise Indium, Gallium oder Aluminium (dreiwertig) fehlt ein Elektron im
Bindungsgefüge.
Daher wurde effektiv auch
noch eine positive Ladung, Loch genannt, generiert und man spricht vom Paar. Diese
sogenannte Eigenleitung ist aber für den Transistor nicht von Nutzen. Es gibt nämlich
noch eine zweite Möglichkeit, Halbleiter leitend zu machen: Die Einbringung von
Fremdatomen in den Kristall (Dotierung). Indem die Siliziumschmelze mit drei- oder
fünfwertigen Atomen gezielt verschmutzt wird, wobei ein übliches Verhältnis von
Grundstoff zu Fremdstoff im resultierenden Kristall 1:1000000 ist, wird das Gefüge
der gebundenen Elektronen im Kristallgitter gestört. Bei Einbringung von z.B. Antimon,
Phosphor oder Arsen (fünfwertig) kann ein Elektron des Fremdatoms nicht gebunden werden,
es ist somit beweglich und der Kristall leitfähig, man spricht von n-Leitendem
Halbleitermaterial mit Fähigkeit zur Störstellenleitung. Bei Verschmutzung mit
beispielsweise Indium, Gallium oder Aluminium (dreiwertig) fehlt ein Elektron im
Bindungsgefüge.  Der freie Platz kann als virtueller positiver Ladungsträger (Loch)
durch den Kristall weiterwandern, indem er von einem Elektron besetzt wird, an
dessen Herkunftsort dann die Fehlstelle ist (=>Leitfähigkeit). Man spricht vom p-leitenden
Halbleiter, der zur Störstellenleitung fähig ist. Im n-Halbleiter nennt man die Elektronen
als hauptsächliche Träger eines Stromes Majoritätsträger, die Löcher Minoritätsträger.
Im p-Kristall ist das ganze umgekehrt. Minoritätsträger werden für gewöhnlich
von Majoritätsträgern neutralisiert, falls sie einmal durch thermische Lösung
eines Elektronen von einem Atom entstehen.
Der freie Platz kann als virtueller positiver Ladungsträger (Loch)
durch den Kristall weiterwandern, indem er von einem Elektron besetzt wird, an
dessen Herkunftsort dann die Fehlstelle ist (=>Leitfähigkeit). Man spricht vom p-leitenden
Halbleiter, der zur Störstellenleitung fähig ist. Im n-Halbleiter nennt man die Elektronen
als hauptsächliche Träger eines Stromes Majoritätsträger, die Löcher Minoritätsträger.
Im p-Kristall ist das ganze umgekehrt. Minoritätsträger werden für gewöhnlich
von Majoritätsträgern neutralisiert, falls sie einmal durch thermische Lösung
eines Elektronen von einem Atom entstehen. Dadurch verringert sich ihre Anzahl in dieser Zone, da
die Störungen im Bindungsgefüge der Elektronen (s.o.) behoben werden. Jedoch fehlen dann
in der n-Zone Elektronen bzw. in der p-Zone Löcher, wodurch die n-Zone positiv und die
p-Zone negativ geladen wird (Entstehung v. Raumladungszonen i. SperrschichtbeŁ- reich,
Abb. 3.4). Das so entstandene elektrische Feld wirkt der Diffusion der Ladungsträger
in die andere Schicht und so der Rekombination entgegen, daher nennt man
die entstandene Spannung zwischen n- und p-Schicht Antidiffusionsspannung. Die Grenzschicht
ist bei Eintreten eines Gleichgewichtes zwischen dem Diffusionsbestreben und der entgegenwirkenden
Spannung durch Verarmung an freien Ladungsträgern, die einen normalen kettenreaktionsartigen
Ladungsträgertransport verhindert, bereits hochohmig. Was passiert aber nun, wenn wir an
unsere Schichten eine Spannung anlegen? Wenn wir an die n-Schicht den Pluspol legen und
an die p-Schicht den Minuspol, werden die vorhandenen Majoritätsträger an die Kontakte
und von der Grenzschicht weg gezogen und damit ist das ganze System ein hochohmiger
Isolator. Die Majoritätsträger kommen also aufgrund der Polung für eine weitere
Stromleitung nicht mehr in Frage.
Dadurch verringert sich ihre Anzahl in dieser Zone, da
die Störungen im Bindungsgefüge der Elektronen (s.o.) behoben werden. Jedoch fehlen dann
in der n-Zone Elektronen bzw. in der p-Zone Löcher, wodurch die n-Zone positiv und die
p-Zone negativ geladen wird (Entstehung v. Raumladungszonen i. SperrschichtbeŁ- reich,
Abb. 3.4). Das so entstandene elektrische Feld wirkt der Diffusion der Ladungsträger
in die andere Schicht und so der Rekombination entgegen, daher nennt man
die entstandene Spannung zwischen n- und p-Schicht Antidiffusionsspannung. Die Grenzschicht
ist bei Eintreten eines Gleichgewichtes zwischen dem Diffusionsbestreben und der entgegenwirkenden
Spannung durch Verarmung an freien Ladungsträgern, die einen normalen kettenreaktionsartigen
Ladungsträgertransport verhindert, bereits hochohmig. Was passiert aber nun, wenn wir an
unsere Schichten eine Spannung anlegen? Wenn wir an die n-Schicht den Pluspol legen und
an die p-Schicht den Minuspol, werden die vorhandenen Majoritätsträger an die Kontakte
und von der Grenzschicht weg gezogen und damit ist das ganze System ein hochohmiger
Isolator. Die Majoritätsträger kommen also aufgrund der Polung für eine weitere
Stromleitung nicht mehr in Frage.  Und zudem wirkt die Tatsache, dass in dem Kristall
(s.o.) keine kettenreaktionsartige Bewegung der Ladungsträger mehr möglich ist, einem
Strom von Minoritätsträgern entgegen. Kann doch einmal ein Minoritätsträger ins System
eindringen, so wird die schon vorhandene, im p-Raum negative und im n-Raum positive
Raumladung noch verstärkt, da der eingedrungene Ladungsträger sich nicht oder nur ganz
schwer durch den geordneten Kristall bewegen kann
und damit zuerst einmal eine quasi-statische Ladung ist. Dies verhindert einen
weiteren Einstrom von Minoritätsträgern. Es fließt nur noch ein minimaler Strom,
der durch zufällig (d.h. thermisch bedingt) in den Zonen irgendwo entstehende
Minoritätsträger getragen wird, die eine Eigenleitung des Kristalls hervorrufen.
Polen wir unsere Spannungsquelle jedoch um (Pluspol an der p-Schicht, Minuspol an
der n-Schicht), werden die Ladungsträger in Richtung der verarmten Sperrschicht
gedrückt, die vorher vorhandenen Raumladungszonen bauen sich ab. An der Sperrschicht
können Elektronen mit Löchern rekombinieren. Die n-Schicht bekommt Elektronen von der
Stromquelle nachgeliefert, während aus der p-Schicht dauernd welche abgesaugt, oder,
anders ausgedrückt, Löcher vom Pluspol nachgeliefert werden. Damit hat ein Stromfluss
Und zudem wirkt die Tatsache, dass in dem Kristall
(s.o.) keine kettenreaktionsartige Bewegung der Ladungsträger mehr möglich ist, einem
Strom von Minoritätsträgern entgegen. Kann doch einmal ein Minoritätsträger ins System
eindringen, so wird die schon vorhandene, im p-Raum negative und im n-Raum positive
Raumladung noch verstärkt, da der eingedrungene Ladungsträger sich nicht oder nur ganz
schwer durch den geordneten Kristall bewegen kann
und damit zuerst einmal eine quasi-statische Ladung ist. Dies verhindert einen
weiteren Einstrom von Minoritätsträgern. Es fließt nur noch ein minimaler Strom,
der durch zufällig (d.h. thermisch bedingt) in den Zonen irgendwo entstehende
Minoritätsträger getragen wird, die eine Eigenleitung des Kristalls hervorrufen.
Polen wir unsere Spannungsquelle jedoch um (Pluspol an der p-Schicht, Minuspol an
der n-Schicht), werden die Ladungsträger in Richtung der verarmten Sperrschicht
gedrückt, die vorher vorhandenen Raumladungszonen bauen sich ab. An der Sperrschicht
können Elektronen mit Löchern rekombinieren. Die n-Schicht bekommt Elektronen von der
Stromquelle nachgeliefert, während aus der p-Schicht dauernd welche abgesaugt, oder,
anders ausgedrückt, Löcher vom Pluspol nachgeliefert werden. Damit hat ein Stromfluss
 durch den Übergang eingesetzt, unser System ist leitend. Jedoch fällt an ihm bei
Durchfluss von Elektronen der Betrag einer Antidiffusionsspannung ab, die von den
Elektronen unter dem Energieverlust e*Uad durchlaufen werden muss. Diese
kommt daher, dass die kräftige Bewegung der Majoritätsträger zu den Polen der
Spannungsquelle und damit zur anderen Zone zu einem Diffusionsschwanz (in Abb.
3.6 als hellere Ladungsträger dargestellt) von Minoritätsträgern in den Zonen
und damit wiederum zu Aufladung von Räumen führt.
durch den Übergang eingesetzt, unser System ist leitend. Jedoch fällt an ihm bei
Durchfluss von Elektronen der Betrag einer Antidiffusionsspannung ab, die von den
Elektronen unter dem Energieverlust e*Uad durchlaufen werden muss. Diese
kommt daher, dass die kräftige Bewegung der Majoritätsträger zu den Polen der
Spannungsquelle und damit zur anderen Zone zu einem Diffusionsschwanz (in Abb.
3.6 als hellere Ladungsträger dargestellt) von Minoritätsträgern in den Zonen
und damit wiederum zu Aufladung von Räumen führt. Nun stellt sich vielleicht die Frage, warum ich so lange über p-n-Übergänge, also Dioden,
referiert habe, obwohl diese Facharbeit Transistoren zum Thema
hat. Die Antwort ist einfach: Transistoren nutzen ebenfalls die Effekte
an p-n-Übergängen aus und damit ist mittels der oben erläuterten Erkenntnisse über Halbleiter
auch eine Betrachtung des Bipolartransistors nicht mehr so schwer, soweit sie in unserem Rahmen
möglich ist. Bipolartransistoren
bestehen aus einem Sandwich von Halbleitermaterial verschiedener Dotierung, wobei das Brot
im npn-Transistor, an dem ich die Transistorfunktion erklären will, aus Material vom n-Typ
und der dünne Aufstrich aus Material vom p-Typ besteht. Die äußeren Schichten heißen
Kollektor (C) und Emitter (E) und sind dicker als die p-Schicht, die Basis (B) genannt wird;
jede Schicht besitzt einen Anschluss, der aus dem Transistorgehäuse geführt ist. Wird an die
npn-Strecke vom Kollektor zum Emitter eine Spannung (Pluspol am Kollektor) angelegt, stellt
sich heraus, dass kein Strom durch den npn-Übergang fließt. Das überrascht auch nicht,
zumal am B-C-Übergang die freien Majoritätsträger durch die anliegende Spannung von der
Grenzschicht weggedrängt werden und
so eine hochohmige Sperrschicht (mit starken Bindungen s.o.) entsteht, die Ladungsträger
nur schlecht durchdringen können.
Nun stellt sich vielleicht die Frage, warum ich so lange über p-n-Übergänge, also Dioden,
referiert habe, obwohl diese Facharbeit Transistoren zum Thema
hat. Die Antwort ist einfach: Transistoren nutzen ebenfalls die Effekte
an p-n-Übergängen aus und damit ist mittels der oben erläuterten Erkenntnisse über Halbleiter
auch eine Betrachtung des Bipolartransistors nicht mehr so schwer, soweit sie in unserem Rahmen
möglich ist. Bipolartransistoren
bestehen aus einem Sandwich von Halbleitermaterial verschiedener Dotierung, wobei das Brot
im npn-Transistor, an dem ich die Transistorfunktion erklären will, aus Material vom n-Typ
und der dünne Aufstrich aus Material vom p-Typ besteht. Die äußeren Schichten heißen
Kollektor (C) und Emitter (E) und sind dicker als die p-Schicht, die Basis (B) genannt wird;
jede Schicht besitzt einen Anschluss, der aus dem Transistorgehäuse geführt ist. Wird an die
npn-Strecke vom Kollektor zum Emitter eine Spannung (Pluspol am Kollektor) angelegt, stellt
sich heraus, dass kein Strom durch den npn-Übergang fließt. Das überrascht auch nicht,
zumal am B-C-Übergang die freien Majoritätsträger durch die anliegende Spannung von der
Grenzschicht weggedrängt werden und
so eine hochohmige Sperrschicht (mit starken Bindungen s.o.) entsteht, die Ladungsträger
nur schlecht durchdringen können. 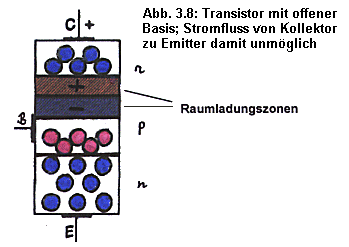 Eine eventuelle Diffusion
von Elektronen in die Basis durch die bei gegebener Polung leitfähige E-B-Sperrschicht
wird dadurch gestoppt, dass in die Basis eindringende Elektronen durch die Sperrschicht
schlecht fließen können, sich die Basis bei Eindringen von schon wenigen Elektronen also
negativ auflädt und dies eine weitere Elektronenbewegung ganz verhindert. Wen man jedoch
an die Basis gegen den Emitter eine weitere positive Spannung Ube anlegt, die
kleiner als die zwischen Kollektor und Emitter und größer als die Antidiffusionsspannung
der B-E-Diode von größenordungnsmäßig 0,7V ist, schafft man es, diese statische Situation
zu lockern. In die Basis kommen wieder positive Ladungsträger, die zum Emitter hin fließen,
und entgegengesetzt kommen aus der Emitterelektrode noch viel mehr Elektronen heraus,
die sich zur Basis bewegen (der Emitter ist stärker dotiert, damit tragen die n-Ladungsträger
aus ihm den Strom in der B-E-Übergangszone hauptsächlich, weil sich aus der schwächer dotierten
Basis auch nur weniger Löcher gleichzeitig zum Emitter bewegen können). Ein Stromfluss
hauptsächlich negativer Ladungsträger hat eingesetzt, da die Basis Elektronen nun nicht
mehr abstößt (die angelegte Spannung hebt die Wirkung der Raumladung auf), und mit ihm
bilden sich am B-E-Übergang die oben (Kapitel p-n-Übergang) genannten Diffusionsschwänze,
wobei der Schwanz der hauptsächlich fließenden Emitterelektronen größer ist. Da die Basis
nur sehr dünn ist, reicht der Diffusionsschwanz dieser Elektronen bis in die zweite
Transistorsperrschicht hinein.
Eine eventuelle Diffusion
von Elektronen in die Basis durch die bei gegebener Polung leitfähige E-B-Sperrschicht
wird dadurch gestoppt, dass in die Basis eindringende Elektronen durch die Sperrschicht
schlecht fließen können, sich die Basis bei Eindringen von schon wenigen Elektronen also
negativ auflädt und dies eine weitere Elektronenbewegung ganz verhindert. Wen man jedoch
an die Basis gegen den Emitter eine weitere positive Spannung Ube anlegt, die
kleiner als die zwischen Kollektor und Emitter und größer als die Antidiffusionsspannung
der B-E-Diode von größenordungnsmäßig 0,7V ist, schafft man es, diese statische Situation
zu lockern. In die Basis kommen wieder positive Ladungsträger, die zum Emitter hin fließen,
und entgegengesetzt kommen aus der Emitterelektrode noch viel mehr Elektronen heraus,
die sich zur Basis bewegen (der Emitter ist stärker dotiert, damit tragen die n-Ladungsträger
aus ihm den Strom in der B-E-Übergangszone hauptsächlich, weil sich aus der schwächer dotierten
Basis auch nur weniger Löcher gleichzeitig zum Emitter bewegen können). Ein Stromfluss
hauptsächlich negativer Ladungsträger hat eingesetzt, da die Basis Elektronen nun nicht
mehr abstößt (die angelegte Spannung hebt die Wirkung der Raumladung auf), und mit ihm
bilden sich am B-E-Übergang die oben (Kapitel p-n-Übergang) genannten Diffusionsschwänze,
wobei der Schwanz der hauptsächlich fließenden Emitterelektronen größer ist. Da die Basis
nur sehr dünn ist, reicht der Diffusionsschwanz dieser Elektronen bis in die zweite
Transistorsperrschicht hinein.  Das heißt, man hat es geschafft, einige Minoritätsträger
(Elektronen) in die p-Basis zu injizieren, die auch meist ohne zu rekombinieren (die Basis
ist dünn und eher schwach dotiert, enthält damit nur wenige Löcher zur Rekombination)
in den Bereich der B-C-Sperrschicht gelangen.ĀDie Ladungsträger werden vom E-Feld des
positiv vorgespannten Kollektoranschlusses erfasst, diffundieren weiter in den Kollektor
und schließlich kommen Elektronen aus dessen Anschlussdraht heraus, statt aus dem
Basisanschluss herauszufließen. Für die aus dem Kollektor herausfließenden Elektronen
liefert die dort angeschlossene Stromquelle wieder entsprechend Elektronen in den
Emitter nach. Daher fließt im Kollektorstromkreis jetzt ein Strom, und er ist deutlich
größer als der Basisstrom, weil die Basis nur wenige Elektronen durch Rekombination mit
aus dem Basisanschluss gekommenen Löchern abzieht; dieses Phänomen nennt man Stromverstärkung.
Vorraussetzung für einen Kollektorstrom ist natürlich, dass eine genügend hohe Spannung
Uce anliegt. Wenn Uce<Ube ist, so heißt das, dass die
B-C-Diode nicht mehr in Sperrrichtung betrieben wird, und damit sehen die in die Basis
injizierten Minoritätsträger auch keinen so großen Anlass mehr, die B-C-Sperrschicht in
Sperrrichtung zum Kollektor hin zu überschreiten, aber dazu noch mehr bei den Kennlinien.
Das heißt, man hat es geschafft, einige Minoritätsträger
(Elektronen) in die p-Basis zu injizieren, die auch meist ohne zu rekombinieren (die Basis
ist dünn und eher schwach dotiert, enthält damit nur wenige Löcher zur Rekombination)
in den Bereich der B-C-Sperrschicht gelangen.ĀDie Ladungsträger werden vom E-Feld des
positiv vorgespannten Kollektoranschlusses erfasst, diffundieren weiter in den Kollektor
und schließlich kommen Elektronen aus dessen Anschlussdraht heraus, statt aus dem
Basisanschluss herauszufließen. Für die aus dem Kollektor herausfließenden Elektronen
liefert die dort angeschlossene Stromquelle wieder entsprechend Elektronen in den
Emitter nach. Daher fließt im Kollektorstromkreis jetzt ein Strom, und er ist deutlich
größer als der Basisstrom, weil die Basis nur wenige Elektronen durch Rekombination mit
aus dem Basisanschluss gekommenen Löchern abzieht; dieses Phänomen nennt man Stromverstärkung.
Vorraussetzung für einen Kollektorstrom ist natürlich, dass eine genügend hohe Spannung
Uce anliegt. Wenn Uce<Ube ist, so heißt das, dass die
B-C-Diode nicht mehr in Sperrrichtung betrieben wird, und damit sehen die in die Basis
injizierten Minoritätsträger auch keinen so großen Anlass mehr, die B-C-Sperrschicht in
Sperrrichtung zum Kollektor hin zu überschreiten, aber dazu noch mehr bei den Kennlinien. Außer diesem Einsatz als
Verstärker ist noch die Schlaltanwendung bekannt. Sie nutzt nur die Zustände "Basisstrom
fließt => Kollektor-Emitter-Strecke offen" und "Basisstrom fließt nicht => Kollektor-Emitter-Strecke
zu". Da die Öffnung der Kollektor-Emitter-Strecke jedoch mit höher werdender Basisleistung
Ube*Ibe langsam und nicht sprunghaft vom Zustand aus auf den Zustand
ein ansteigt, muss man sich eventuell noch eine Schaltung um den Transistor herum einfallen
lassen, die den Bereich des Umkippens von 0 auf 1 möglichst gering macht und möglichst davor
den Zustand völlig aus und danach völlig ein erzeugt, sowie den Umkipppunkt nach den gegebenen
Anforderungen definiert. Auch bei dieser Nutzung des Transistors sind natürlich wie in der
Verstärkeranwendung nur begrenzte Schaltfrequenzen möglich.
Außer diesem Einsatz als
Verstärker ist noch die Schlaltanwendung bekannt. Sie nutzt nur die Zustände "Basisstrom
fließt => Kollektor-Emitter-Strecke offen" und "Basisstrom fließt nicht => Kollektor-Emitter-Strecke
zu". Da die Öffnung der Kollektor-Emitter-Strecke jedoch mit höher werdender Basisleistung
Ube*Ibe langsam und nicht sprunghaft vom Zustand aus auf den Zustand
ein ansteigt, muss man sich eventuell noch eine Schaltung um den Transistor herum einfallen
lassen, die den Bereich des Umkippens von 0 auf 1 möglichst gering macht und möglichst davor
den Zustand völlig aus und danach völlig ein erzeugt, sowie den Umkipppunkt nach den gegebenen
Anforderungen definiert. Auch bei dieser Nutzung des Transistors sind natürlich wie in der
Verstärkeranwendung nur begrenzte Schaltfrequenzen möglich.
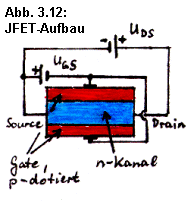


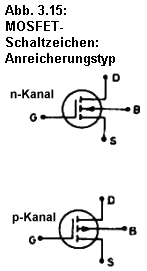

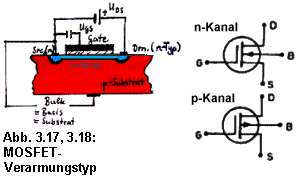
 Als allererstes Herstellungsverfahren beschrieb Shockley 1951 eine Methode,
bei der man die nötige n-p-n-Struktur direkt beim Ziehen herstellt. Zuerst
gibt man der Halbleiterschmelze für den Kollektor eine eher schwache n-Dotierung
in Form eines geeigneten verunreinigenden Elementes zu, zieht den Kristall
ein Stück aus der Schmelze und überdeckt dann die n-Dotierung durch Einbringung
genügend dreiwertiger Atome, die den Halbleiter im späteren Basisbereich
p-leitend machen. Nun muss schon nach einer geringen
gezogenen Schichtdicke wieder ausreichend fünfwertiges Material zugegeben werden, um den
Emitter mit besonders hoher Dotierung zu erzeugen. Man erhält einen zwiebelförmigen,
oben und unten n-dotierten Kristall, der in der Mitte eine dünne, quer verlaufende
p-Schicht enthält. Nun schneidet man den Kristall längs zur Zugrichtung
in Scheiben und diese schließlich ebenfalls längs zur Zugrichtung in Einzelstücke.
Schließlich werden die Transistoren nach eventuell noch anderen Schritten
in einem Lötvorgang kontaktiert, wobei die Basis erst wieder durch Oberflächenabtastungsmethoden
ausfindig gemacht werden muss. Man beachte, dass für die Kontaktierung von
Halbleiterschichten bei diesem und allen Verfahren solche Metalle oder Metalllegierungen
als Kontakte ausgewählt werden müssen, die mit dem Halbleiter keinen Schottky-Kontakt,
sondern einen Kontakt mit gewöhnlicher ohmscher Übertragungscharakteristik
bilden.
Als allererstes Herstellungsverfahren beschrieb Shockley 1951 eine Methode,
bei der man die nötige n-p-n-Struktur direkt beim Ziehen herstellt. Zuerst
gibt man der Halbleiterschmelze für den Kollektor eine eher schwache n-Dotierung
in Form eines geeigneten verunreinigenden Elementes zu, zieht den Kristall
ein Stück aus der Schmelze und überdeckt dann die n-Dotierung durch Einbringung
genügend dreiwertiger Atome, die den Halbleiter im späteren Basisbereich
p-leitend machen. Nun muss schon nach einer geringen
gezogenen Schichtdicke wieder ausreichend fünfwertiges Material zugegeben werden, um den
Emitter mit besonders hoher Dotierung zu erzeugen. Man erhält einen zwiebelförmigen,
oben und unten n-dotierten Kristall, der in der Mitte eine dünne, quer verlaufende
p-Schicht enthält. Nun schneidet man den Kristall längs zur Zugrichtung
in Scheiben und diese schließlich ebenfalls längs zur Zugrichtung in Einzelstücke.
Schließlich werden die Transistoren nach eventuell noch anderen Schritten
in einem Lötvorgang kontaktiert, wobei die Basis erst wieder durch Oberflächenabtastungsmethoden
ausfindig gemacht werden muss. Man beachte, dass für die Kontaktierung von
Halbleiterschichten bei diesem und allen Verfahren solche Metalle oder Metalllegierungen
als Kontakte ausgewählt werden müssen, die mit dem Halbleiter keinen Schottky-Kontakt,
sondern einen Kontakt mit gewöhnlicher ohmscher Übertragungscharakteristik
bilden. Die nächste und auch bedeutendere Bauform war der Legierungstransistor,
dessen Ausgangsmaterial eine dünne, kleine Scheibe (auch Wafer) aus n-Germanium-Kristall
ist. Man setzt auf diese Scheibe auf beiden Seiten Pillen (Pellets) von
Indium und erwärmt die Anordnung auf eine Temperatur, bei der das Indium
schon gut, das Germanium (höherer Schmelzpunkt) aber noch überhaupt nicht
schmilzt. Bei diesem Vorgang gelangen dreiwertige Atome in das Germanium
und dotieren es an den Übergangszonen um, so dass eine pnp-Schichtfolge entsteht.
Schließlich werden die beiden Pillen mit angelötetem Silberdraht und die
Basis meist mit Hilfe eines auf den Kristall gelöteten Metallringes um die
Emitterpille kontaktiert. Auf ähnliche Art kann man einen p-leitenden Germaniumkristall
mittels Arsen oder Antimon zu einem npn-Transistor machen, ebenso können
auch Siliziumtransistoren mit Aluminium als Pillenmaterial hergestellt werden,
allerdings gestaltet sich das aufgrund besonderer Materialeigenschaften
schwieriger.
Die nächste und auch bedeutendere Bauform war der Legierungstransistor,
dessen Ausgangsmaterial eine dünne, kleine Scheibe (auch Wafer) aus n-Germanium-Kristall
ist. Man setzt auf diese Scheibe auf beiden Seiten Pillen (Pellets) von
Indium und erwärmt die Anordnung auf eine Temperatur, bei der das Indium
schon gut, das Germanium (höherer Schmelzpunkt) aber noch überhaupt nicht
schmilzt. Bei diesem Vorgang gelangen dreiwertige Atome in das Germanium
und dotieren es an den Übergangszonen um, so dass eine pnp-Schichtfolge entsteht.
Schließlich werden die beiden Pillen mit angelötetem Silberdraht und die
Basis meist mit Hilfe eines auf den Kristall gelöteten Metallringes um die
Emitterpille kontaktiert. Auf ähnliche Art kann man einen p-leitenden Germaniumkristall
mittels Arsen oder Antimon zu einem npn-Transistor machen, ebenso können
auch Siliziumtransistoren mit Aluminium als Pillenmaterial hergestellt werden,
allerdings gestaltet sich das aufgrund besonderer Materialeigenschaften
schwieriger.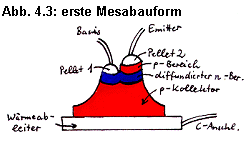 Schon 1956 wurde eine noch andere, ebenfalls mit obigem Diffusionsverfahren verwandte Dotiertechnik
das erste mal genutzt. Dabei legiert man auf einen p-Germaniumkristall zwei
Pellets von entgegengesetzt dotierenden Störstoffen auf. Das ganze wird nun
stark erwärmt, wobei die n-störenden Atome schneller in das an Elektronen
arme p-Germanium diffundieren und eine n-leitende Schicht im gesamten Oberflächenbereich
bilden, bevor die p-Atome zu diffundieren beginnen und auf die n-Zone noch
einmal eine p-Zone setzen; die resultierende Schichtfolge ist also pnp,
am Kristall wird der Kollektor kontaktiert und an den Pillen Basis und Emitter.
Die oberen Schichten des Transistors werden zur Verbesserung der elektrischen
Eigenschaften bis zur Stelle, wo die Pillen sitzen, seitlich weggeätzt (die
von den Pillen entfernten Bereiche erfüllen keine Funktion und stellen unnötigen
kapazitiven Ballast dar), was diesem Transistor das Aussehen eines Tafelbergs,
spanisch "Mesa", gab.
Schon 1956 wurde eine noch andere, ebenfalls mit obigem Diffusionsverfahren verwandte Dotiertechnik
das erste mal genutzt. Dabei legiert man auf einen p-Germaniumkristall zwei
Pellets von entgegengesetzt dotierenden Störstoffen auf. Das ganze wird nun
stark erwärmt, wobei die n-störenden Atome schneller in das an Elektronen
arme p-Germanium diffundieren und eine n-leitende Schicht im gesamten Oberflächenbereich
bilden, bevor die p-Atome zu diffundieren beginnen und auf die n-Zone noch
einmal eine p-Zone setzen; die resultierende Schichtfolge ist also pnp,
am Kristall wird der Kollektor kontaktiert und an den Pillen Basis und Emitter.
Die oberen Schichten des Transistors werden zur Verbesserung der elektrischen
Eigenschaften bis zur Stelle, wo die Pillen sitzen, seitlich weggeätzt (die
von den Pillen entfernten Bereiche erfüllen keine Funktion und stellen unnötigen
kapazitiven Ballast dar), was diesem Transistor das Aussehen eines Tafelbergs,
spanisch "Mesa", gab. Jeder obenliegende n-Bereich stellt einen Emitter für einen Transistor
dar; die Transistoren werden getrennt. Die Kontaktierung erfolgt am Emitter
durch Einlegieren eines Goldfilms als Anschluss und im Basisbereich auf
selbige Weise mit Aluminium. An der Unterseite findet sich der Kollektoranschluss,
der gleichzeitig als Wärmeableiter konzipiert ist. Wenn eine konventionelle
Kontaktierung bei kleinen Bauformen nicht mehr möglich ist, muss man zum
Thermokompressionsverfahren greifen, in dem man einen feinen Golddraht über
der Kontaktstelle platziert und mittels einer Spitze bei etwa 300░C in Schutzgas
andrückt. Neben solchen npn-Transistoren kann man auf ähnliche Weise auch
eine pnp-Bauform erzeugen. Auch hier werden die Transistoren wie beim älteren
Typ zu einer Mesa-Form geätzt.
Jeder obenliegende n-Bereich stellt einen Emitter für einen Transistor
dar; die Transistoren werden getrennt. Die Kontaktierung erfolgt am Emitter
durch Einlegieren eines Goldfilms als Anschluss und im Basisbereich auf
selbige Weise mit Aluminium. An der Unterseite findet sich der Kollektoranschluss,
der gleichzeitig als Wärmeableiter konzipiert ist. Wenn eine konventionelle
Kontaktierung bei kleinen Bauformen nicht mehr möglich ist, muss man zum
Thermokompressionsverfahren greifen, in dem man einen feinen Golddraht über
der Kontaktstelle platziert und mittels einer Spitze bei etwa 300░C in Schutzgas
andrückt. Neben solchen npn-Transistoren kann man auf ähnliche Weise auch
eine pnp-Bauform erzeugen. Auch hier werden die Transistoren wie beim älteren
Typ zu einer Mesa-Form geätzt.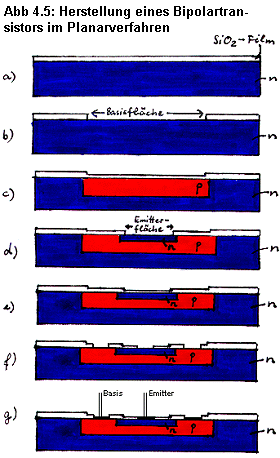 Zunächst wird eine dünn
geätzte, in diesem Beispiel n-dotierte Si-Scheibe oft auch mit epitaktischer
Schicht an der Oberseite) mit Siliziumdioxid (Schritt a) und einem lichtempfindlichen
Photolack überzogen. Dann belichtet man die Scheibe durch eine Maske mit
kleinen Fenstern (ca. 1000 Fenster auf einer Kristallscheibe mit 2,5cm Durchmesser!).
Der Photolack wird nun chemisch entwickelt, d.h. er löst sich an den belichteten
Stellen auf, und danach lässt man ihn, wo er verblieben ist, aushärten.
Nun wird das Plättchen einer Ätzlösung ausgesetzt, die den Photolack in
der Ätzzeit nicht aufzulösen vermag, wohl aber die freiliegenden Siliziumdioxidbereiche.
An den vorher belichteten Stellen liegt also das Silizium frei (Schritt
b), und man kann es unter hohen Temperaturen einem Bordampf aussetzen, der
p-dotierte Zonen unter den Fenstern schafft. Nun oxidiert und lackiert man noch mal (Schritt c) und belichtet
diesmal durch kleinere Fenster, deren Mittelpunkte an denselben Stellen
wie vorher liegen. Der Lack wird entwickelt und es wird geätzt (Schritt
d), diesmal liegen kleinere Teilflächen der p-Flächen frei. Hier lässt
man n-dotierende Atome von Phosphor nach demselben Verfahren wie oben eindiffundieren,
wodurch schließlich die Schichtfolge n-p-n entstanden ist. Noch einmal
folgt ein Oxidations- (Schritt e) / Belichtungs- / Ätzvorgang, bei dem sich am Schluss genau Fenster an den Anschlussstellen
für die p-dotierten Basen (siehe Bild) und die ganz oben liegenden n-Emitter
befinden (Schritt f; der Kollektor kann an der Unterseite des Kristalls
angeschlossen werden). In einer Vakuumkammer dampft man auf die gesamte
Plättchenfläche Aluminium zur Kontaktierung auf, und ätzt dann nach einer
Fotomaskierung die nicht benötigten Aluminiumzonen wieder frei. Man zerlegt
das Plättchen in Einzeltransistoren und kontaktiert mittels Thermokompressionsverfahren
(Schritt g).
Zunächst wird eine dünn
geätzte, in diesem Beispiel n-dotierte Si-Scheibe oft auch mit epitaktischer
Schicht an der Oberseite) mit Siliziumdioxid (Schritt a) und einem lichtempfindlichen
Photolack überzogen. Dann belichtet man die Scheibe durch eine Maske mit
kleinen Fenstern (ca. 1000 Fenster auf einer Kristallscheibe mit 2,5cm Durchmesser!).
Der Photolack wird nun chemisch entwickelt, d.h. er löst sich an den belichteten
Stellen auf, und danach lässt man ihn, wo er verblieben ist, aushärten.
Nun wird das Plättchen einer Ätzlösung ausgesetzt, die den Photolack in
der Ätzzeit nicht aufzulösen vermag, wohl aber die freiliegenden Siliziumdioxidbereiche.
An den vorher belichteten Stellen liegt also das Silizium frei (Schritt
b), und man kann es unter hohen Temperaturen einem Bordampf aussetzen, der
p-dotierte Zonen unter den Fenstern schafft. Nun oxidiert und lackiert man noch mal (Schritt c) und belichtet
diesmal durch kleinere Fenster, deren Mittelpunkte an denselben Stellen
wie vorher liegen. Der Lack wird entwickelt und es wird geätzt (Schritt
d), diesmal liegen kleinere Teilflächen der p-Flächen frei. Hier lässt
man n-dotierende Atome von Phosphor nach demselben Verfahren wie oben eindiffundieren,
wodurch schließlich die Schichtfolge n-p-n entstanden ist. Noch einmal
folgt ein Oxidations- (Schritt e) / Belichtungs- / Ätzvorgang, bei dem sich am Schluss genau Fenster an den Anschlussstellen
für die p-dotierten Basen (siehe Bild) und die ganz oben liegenden n-Emitter
befinden (Schritt f; der Kollektor kann an der Unterseite des Kristalls
angeschlossen werden). In einer Vakuumkammer dampft man auf die gesamte
Plättchenfläche Aluminium zur Kontaktierung auf, und ätzt dann nach einer
Fotomaskierung die nicht benötigten Aluminiumzonen wieder frei. Man zerlegt
das Plättchen in Einzeltransistoren und kontaktiert mittels Thermokompressionsverfahren
(Schritt g).